Тогда ток во внешней цепи и выходная мощность определяется соответственно выражениями (33), (34)
![]()

Относительный максимум выходной мощности составляет 1; 0,77; 0,57; 0,27 и 0,14 при R
S, равном соответственно 0; 1; 2; 5; и 10 Ом. Последовательное сопротивление солнечного элемента зависит от глубины залегания перехода, концентрации примесей в n- и p-областях и от конструкции лицевого омического контакта. Для типичного кремниевого солнечного элемента с геометрией, показанной на рис. 9, последовательное сопротивление составляет ~0,7 Ом для элементов с p-базой и ~0,4 Ом для элементов с n-базой. Это различие в величинах сопротивления обусловлено в основном относительно низким сопротивлением подложек n-типа.Фактор заполнения FF: (35)
![]()
Эффективность преобразования (к. п. д.) элемента равна (36)
![]()
Для получения максимального к. п. д. следует максимизировать все три сомножитель в числителе в правой части выражения(36).
В реальных элементах прямой ток может определяться рекомбинацией носителей в обедненном слое. При этом эффективность преобразования, вообще говоря, ниже, чем в идеальном диоде. В случае одноуровневых рекомбинационных центров рекомбинационный ток можно записать в виде (37), где (37а)
![]()

И в этом случае выражение для эффективности преобразования легко получить с помощью простых уравнений, аналогичных формулам (4)-(9), в которых величину I
S следует заменить на I'S, а показатель экспоненты на 2. Эффективность преобразования в том случае, когда прямой ток определяется рекомбинацией в обедненном слое, оказывается значительно меньше, чем в идеальном диоде, что обусловлено уменьшением как Vxx, так и фактора заполнения. В кремниевых солнечных элементах при 300 К рекомбинационный ток приводит к снижению эффективности преобразования на 25 %.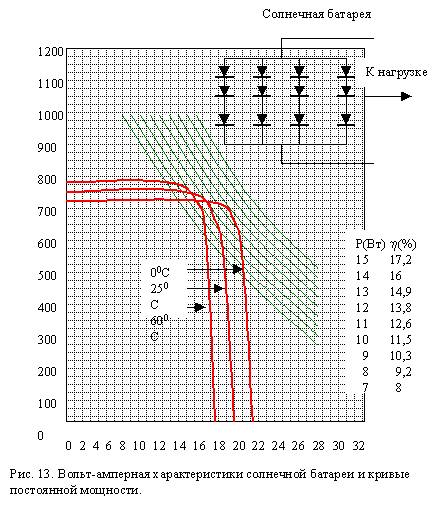
В солнечных элементах, в которых диффузионный и рекомбинационационые токи сравнимы по величине или содержится много дефектов, экспоненциальная зависимость прямого тока от смещения перехода может иметь вид exp(qV/nkT), где величена n называется фактором идеальности. Обычно эффективность преобразования уменьшается с увеличением n.
Хотя отдельный кремниевый солнечный элемент площадью 2 см
2 имеет напряжение холостого хода лишь 0,5-0,6 В и ток короткого замыкания от 30 до 60 мА, последовательно-параллельое соединение таких элементов в большую батарею позволяет подводить к нагрузке существенно большое напряжение и токи. Эквивалентная схема такой солнечной батареи показана на рис. 13. Эта батарея при температуре 600С вырабатывает мощность 10 Вт с к. п. д.=11,5% при АМ1 (~100 мВт/см2); вольт-амперная характеристика касается соответствующей кривой постоянной мощности. Значения Vm и Im, соответствующие максимальному выделению мощности батареей, равны 14 В и 720 мА соответственно. Работа при пониженных температурах позволяет повысить выходную мощность и к. п. д. батареи.6.1. Влияние температуры и радиации.
При увеличении температуру диффузионные длины в Si и GaAs возрастают, поскольку коэффициент диффузии не изменяется либо растет, а время жизни неосновных носителей возрастает при повышении температуры. Увеличение диффузной длины неосновных носителей приводит к возрастанию J
L. Однако величена VXX при этом уменьшается быстрее за счет экспоненциальной зависимости тока насыщения от температуры. Кроме того, более плавная форма вольт-амперной характеристики при повышенных температурах приводит к уменьшению фактора заполнения. Поэтому в целом повышение температуры приводит к уменьшению эффективности преобразования.Нормированные значения к. п. д. для солнечных батарей на Si и GaAs приведены на рис. 14. В условиях протекания идеального тока эффективность линейно уменьшается с возрастанием температуры вплоть до~200
0C для Si и до~3000С для GaAs. При протекании рекомбинационного тока к. п. д. Также уменьшается с увеличением температуры примерно по линейному закону. Из рис. 14 видно, что повышение рабочей температуры элемента всегда приводит к снижению к. п. д.В космических условиях выходная мощность солнечных элементов понижается с связи с тем, что облучение частицами высоких энергий на удельных орбитах приводит к образованию дефектов в полупроводнике. Поэтому важно уметь оценивать продолжительность периода работоспособности космических солнечных батарей. Эта продолжительность определяется временем, в течение которого выходная мощность солнечной батареи достаточна для функционирования аппаратуры спутник.
Из выражения (22) и (26) видно, что фототок уменьшается с уменьшением диффузионных длин L
n и Lp. Время жизни избыточных неосновных носителей при облучении полупроводника частицами высоких энергий меняется по закону (38)![]()
где
t 0 - исходное время жизни, К' - постоянная и Ф - доза радиации. Из этого выражения следует, что скорость рекомбинации неосновных носителей пропорциональна исходной концентрации рекомбинационных центров и их концентрации, вводимой в полупроводник в процессе обучения, причем последняя концентрация пропорциональна дозе попадающих на полупроводник частиц. Посколку диффузная длина равна![]()
где L
0 - исходная диффузная длина и К=К'/D. На рис. 15 приведены измеренные зависимости диффузионной длины для трех кремниевых солнечных элементов от дозы облучения электронами с энергией 1МэВ. Элемент с p-базой, чувствительный в глубокой области спектра, имеет диффузионный слой n-типа и просветляющее покрытие. Диффузионная длина в этом элементе выбрана такой, чтобы обеспечить максимальный спектральный отклик в голубой области спектра (0,45-0,5 мкм), на которую приходится максимум энергии солнечного излучения. Чувствительный в голубой области спектра элемент с n-базой аналогичен рассмотренному выше элементу с p-базой, за исключением того, что области n- и p-типа здесь меняются местами. Мы видим, что экспериментальные результаты для этих элементов неплохо описываются уравнением (39). Кривая, проходящая через экспериментальные точки элемента с p-базой, рассчитана с помощью формулы (39) при L0=119 мкм и К=1,7*10-10. Экспериментальные точки для чувствительного в голубой области элемента с n-базой и обычного элемента с n-базой можно аппроксимировать с помощью формулы (39) при L0=146 мкм и К=1,22*10-8. Из рис.15 видно, что радиационная стойкость элементов с p-базой.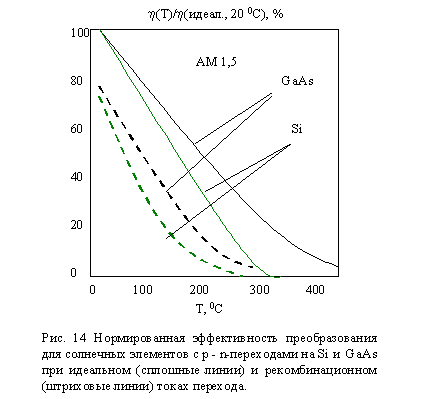
Для повышения радиационной стойкости в солнечные элементы вводится литий, который легко диффундирует и образует комплексы с радиационными точечными дефектами. Очевидно, Li нейтрализует дефекты и препятствует деградации времени жизни. Для снижения числа частиц высоких энергий, достигающих элемента в космическом пространстве, перед лицевой поверхностью элемента всегда должно помещаться защитное покрытие (например, содержащая церий тончайшая бумага).
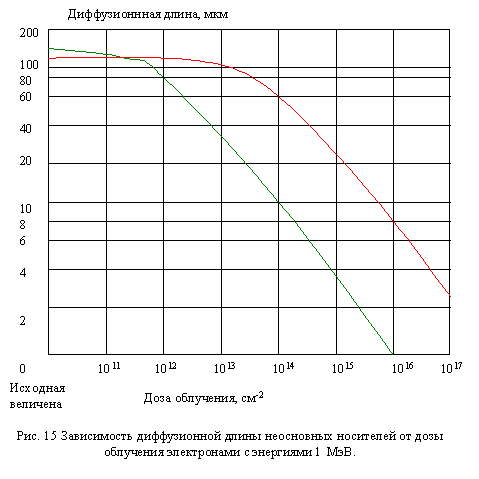
Для достижения более высокой эффективности преобразования предлагалось большое число различных конструкций солнечных элементов. Мы рассмотрим некоторое из них.
Солнечные элемент с барьером вблизи тыловой поверхности (БТП) имеет существенно большее выходное напряжение, чем обычные элементы. Зонная диаграмма такого элемента показана на рис. 16. Лицевая поверхность этого элемента изготавливается обычным способом, а вблизи тыловой поверхности перед металлическим омическим контактом создается сильнолегированный полупроводниковый слой. Потенциальный барьер qj p, возникающий между двумя базовыми областями, препятствует входу неосновных носителей из менее легированной области. Элемент с БТП эквивалентен xi+W+Wp и с очень малой скоростью поверхностной рекомбинации вблизи тыловой поверхности (Sn< 100 см/с). Уменьшение Sn приводит к увеличению спектрального отклика для фотонов с малыми энергиями, а следовательно, и к возрастанию плотности тока короткого замыкания. Кроме того, повышается напряжение холостого хода, что обусловлено возрастанием тока короткого замыкания, уменьшением рекомбинационного тока тылового контакта и, наконец, появлением дополнительной потенциальной энергии qj p между p- и p+-областями.
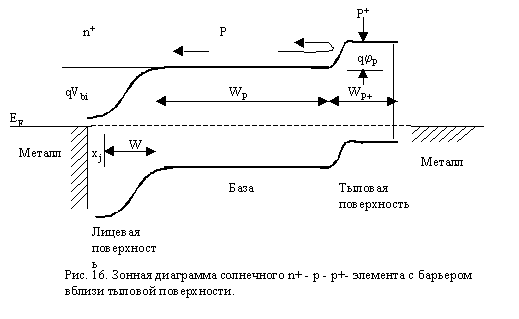
Для создания "фиолетовых" элементов используют пониженную концентрацию легирующей примеси вблизи лицевой поверхности и меньшую глубину залегания перехода. При этом благодаря повышению времени жизни неосновных носителей вблизи лицевой поверхности и относительно узкому лицевому легированному слою спектральный отклик для высокоэнергетичных фотонов сильно возрастает. На рис. 17 для сравнения представлены вместе результаты измерений спектрального отклика обычного элемента с x
j=0,4 мкм и ND=5*1018 см-3. Видно, что "фиолетовый" элемент имеет существенно больший спектральный отклик в фиолетовой области спектра (hn > 2,75 эВ); отсюда происходит название этого элемента. Форма его спектрального отклика напоминает представленную на рис. 11, б теоретическую кривую, относящуюся к случаю, когда скорость поверхностной рекомбинации на лицевой поверхности Sp@ 104 см/с.На рис. 18, а показан текстурированный элемент, лицевая поверхность которого покрыта пирамидами с помощью анизотропного травления поверхности кремния, ориентированной в направлении
a 100n . Свет, падающий на боковую поверхность одной из пирамид, отражаются на другую пирамиду, что приводит к уменьшению оптических потерь. Коэффициент отражения чистого кремния уменьшается с ~20 % для текстурированной поверхности. Нанесение дополнительного просветляющего покрытия снижает потери на отражении вплоть до нескольких процентов (рис. 18, б). Уменьшение отражения приводит к возрастанию как тока короткого замыкания, так и напряжения холостого хода, что в свою очередь повышает эффективность преобразования. Для текстурированных элементов в условиях АМО получен к. п. д. выше 15 %.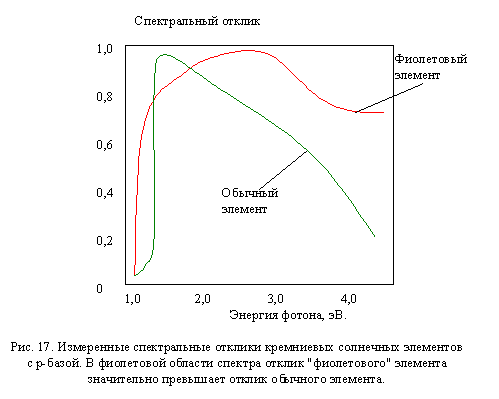
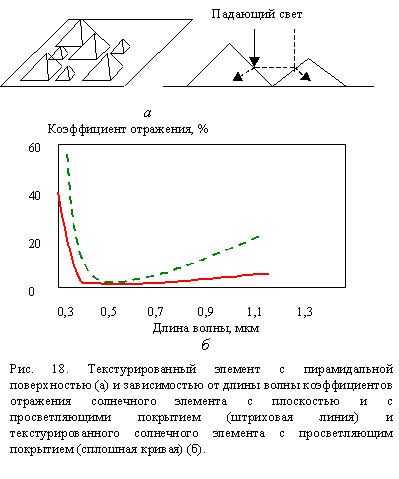
Был предположен еще один новый тип солнечных элементов, использующий анизотропное травление поверхности кремния с ориентацией
a 100n , - много переходные элементы на V-каналах. Такой элемент состоит из ряда отдельных p+ - p - n+ (или p+- p - n+)-диодов, соединенных последовательно (рис. 19, а). Трапециидальная форма отдельных диодов получается за счет анизотропного травления поверхности кремния a 100n через маску термически выращенной двуокиси кремния. Эффективная оптическая толщина такого диода показана на рис. 19, б. При толщине диода 50 мкм эффективная оптическая длина, усредненная по различным траекториям света, превышает 250 мкм. Вследствие этого эффективность фундаментального поглощения (т. е. отношение числа поглощенных фотонов к полному числу фотонов с энергией hn ? Eg, попадающих в полупроводник) превышает 93 %. В результате повышенной эффективности поглощения, относительно низкого последовательного сопротивления и отсутствия затенения лицевой поверхности (в этой конструкции нет коллектирующей гребенки) можно ожидать, что данный элемент будет иметь к. п. д. выше 20 %.

На рис. 20, а показан солнечный элемент со спаренными переходами, в котором сочетаются концепции элемента с БТП и текстурированного элемента. В этом элементе нет тени от металла и облегчаются проблемы межсоединений благодаря тому, что n
+- и p+- контакты создаются на тыловой поверхности. Прибор работает как биполярный транзистор с изолированным n+-эмиттером на лицевой поверхности (рис. 20, б). Электроны, генерируемые светом в эмиттере или в базе, собираются n+-коллектором, подобно тому как это имеет место в транзисторе. В таком элементе зависимость тока короткого замыкания от толщины прибора совершенно непохожа на соответствующие зависимости для обычных солнечных элементов. Для сравнения такие зависимости приведены на рис. 20, в. В солнечных элементах со спаренными переходами используются гораздо более тонкие базовые области, и к. п. д. этих элементов также превышать 20 %.Еще одной конструкций являются солнечные элементы с вертикальными переходами, в которых поверхности переходов и металлические поверхности расположены перпендикулярно поверхности элемента. Прибор с вертикальными переходами схематически представлены на рис. 21. Диффузионные и металлические контакты расположены в глубоко вытравленных каналах, перпендикулярных поверхности и созданных благодаря анизотропному травлению поверхности кремния
a 110n . Расстояние между каналами равно 140 мкм, что составляет величину того же порядка, что и диффузия с лицевой поверхности не проводиться, а доля затененной поверхности благодаря небольшой ширине каналов (10 мкм) не превышает 7 %. Контактные плоскости к каждому выводу и просветляющее покрытие на этом рисунке не показаны.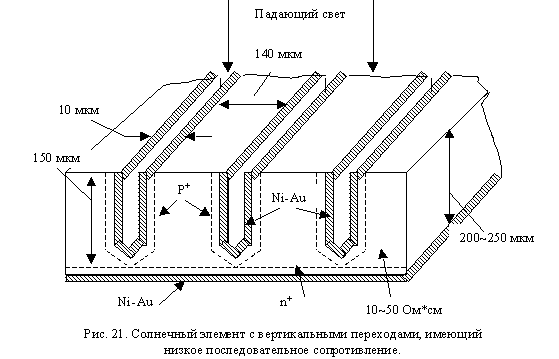
В солнечном элементе с вертикальными переходами ток протекает непосредственно через диффузионные p+-области и металлический слой, расположенные на стенках канавок, и выводиться через контактные полоски, лежащие на боковых поверхностях элемента. Эти полоски соединяют все элементы параллельно, вследствие чего последовательное сопротивление прибора оказывается очень малыми. На таких элементах в условиях АМ1 экспериментально были получены следующие результаты: V
xx=0,59 B, JKЗ=33 мА/см2, фактор заполнения FF=0,80, к. п. д. =15,6 %.Многие из названных выше конструкций были предложены специально для использования в условиях высокой интенсивности излучения. Поэтому их рабочие характеристики обсуждаются в раз. 8.
7. Солнечные элементы с гетеропереходами. Поверхностные и тонкопленочные солнечные элементы.
7.1. Солнечные элементы с гетеропереходами.
Гетеропереходы представляют собой переходы, образующиеся при контакте двух полупроводников с различными энергетическими положениями запрещенной зоны. Типичная энергетическая диаграмма n-p-гетероперехода, находящегося в состоянии термодинамического равновесия, показана на рис. 22. Фотоны с энергией, меньшей E
g1, но большей Eg2, будут проходить через слой первого полупроводника, который играет роль оптического окна, и поглощается во втором полупроводнике. Носители, генерируемые излучением внутри обедненного слоя и в электронейтральном объеме полупроводника в пределах диффузионной длины от перехода, будут коллектироваться переходом подобно тому, как это имеет место в солнечных элементах с n - p-гомопереходами. Фотоны с энергией, большей Eg1, поглощаются в первом полупроводнике, и переход будет коллектировать носители, генерируемые этим излучением на расстоянии от перехода, не превышающем диффузионную длину, либо непосредственно в области пространственного заряда перехода.Преимущества солнечных элементов с гетеропереходами перед обычными солнечными элементами с p - n-переходами состоят в следующем: 1) в увеличении спектрального отклика в коротковолновом диапазоне при условии, что энергия Eg1 достаточно велика и фотоны с высокой энергией поглощаются в обедненном слое второго полупроводника; 2) в понижении последовательного сопротивления при условии, что первый полупроводник можно сильно легировать, не ухудшая при этом условия прохождения света через него; 3) в высокой радиационной стойкости, если первый слой полупроводника достаточно толстый и полупроводник имеет широкую запрещенную зону.
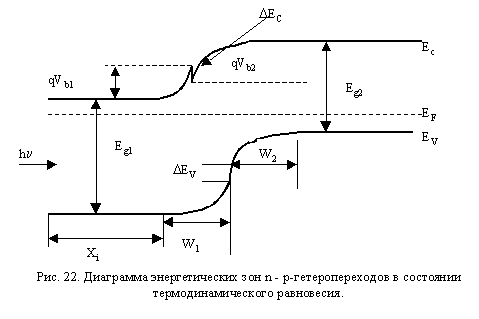
Выражения для фототока в гетеропереходах весьма близки к выражениям для фототока в гомопереходах. В случае n - p-гетеропереходах плотность дырочного фототока в первом полупроводнике (22), в котором
a следует заменить на a 1 и Lp на Lp1, где a 1 и Lp1 - соответственно коэффициент поглощения и диффузионная длина в первом полупроводнике. Плотность электронного тока определяется формулой (26), в которой следует заменить a на a 2, Ln на Ln2 и a (xi + W) на [a 1 (xi + W1) + a 2W2], где a 2 и Ln2 - соответствующие параметры второго полупроводника, а W1 и W2 - толщины обедненного слоя в этих двух полупроводниках. Фототок обедненных слоев равен (40)![]()
Рассмотренные выше выражения для фототока получены при следующих предположениях: 1) скачек зон проводимости
D EC мал (если речь идет о p - n-гетеропереходах, должна быть мала и величина D Ev) и не мешает протеканию неосновных носителей из второго полупроводника через переход; 2) решетки обоих полупроводников хорошо согласуются между собой, вследствие чего плотность поверхностных состояний в гетеропереходе оказывается малой и не снижает время жизни как внутри, так и около обедненного слоя. Спектральный отклик гетеропереходов описывается выражением, подобным формуле (29). Его длинноволновая граница определяется величиной Eg2, а отклик в коротковолновой части спектра зависит от ширины запрещенной зоны и толщины первого полупроводника. Если Eg1 существенно больше Eg2 и рекомбинация на лицевой поверхности гетероперехода пренебрежимо мала, то форма спектрального отклика близка к кривым, приведенным на рис. 11, б, при Sp < 104 см/с. И наоборот, увеличение D EC и плотности состояний на поверхности гетероперехода приведет к снижению спектрального отклика.В качестве производного от слова "солнечный элемент с лицевой гетероповерхностью" для обозначения элементов с p - n-гомопереходом и добавленным к нему слоем полупроводника с большей шириной запрещенной зоны. На рис. 23 показана зонная диаграмма элемента p-Ga
1-xAlxAs/p-GaAs/n-GaAs. Широкозонный полупроводник здесь используется в качестве оптического окна, пропускающего фотоны с энергией, меньшей Eg1. Фотоны с энергиями в диапазоне Eg2 - Eg1 создают носители в гомопереходе. Если коэффициент поглощения света в узкозонном полупроводнике большой, генерация носителей будет происходить в обедненном слое или в близлежащей области и эффективность собирания носителей окажется высокой. Если полупроводниковый материал лицевой гетероповерхности имеет непрямую запрещенную зону лицевой гетероповерхности имеет не прямую запрещенную зону (как, например, Ga1-l All As при x> 0,4) и его достаточно тонкий, то многие фотоны с энергией hn > Eg1 будут проходить через этот слой и генерировать носители непосредственно в узкозонном полупроводнике. На рис. 23 приведены нормированные зависимости спектрального отклика для нескольких солнечных элементов из Ga1-x AlxAs - GaAs, имеющих одинаковые уровни легирования и одинаковую глубину перехода. При увеличении x ширина запрещенной зоны Eg1 увеличивается, поэтому возрастает спектральный отклик в коротковолновой области спектра.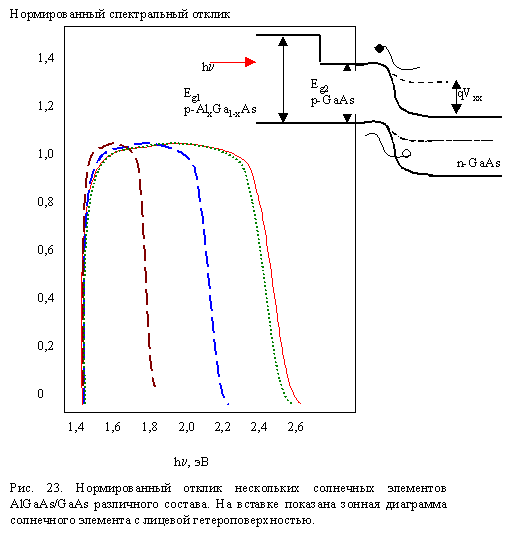
Интересным примером солнечного элемента с гетеропереходом является гетеропереход проводящее стекло - полупроводник. К проводящим стеклам относятся окисные полупроводники, такие как окисел индия (In
2O3 c Eg=3,5 эВ и электронным сродством c =4,45 эВ), окисел олова (SnO2 c Eg=3,5 эВ и электронным сродством c =4,8 эВ) и окисел сплава индия и олова (ITO, смесь In2O3 и SnO2 c Eg=3,7 эВ и электронным сродством c от 4,2 до 4,5 эВ). Эти окисные полупроводники в виде тонких пленок обладают значительным сочетанием хорошей электрической проводимости и высокой оптической прозрачности. Поэтому они играют роль части гетероперехода и просветляющего покрытия.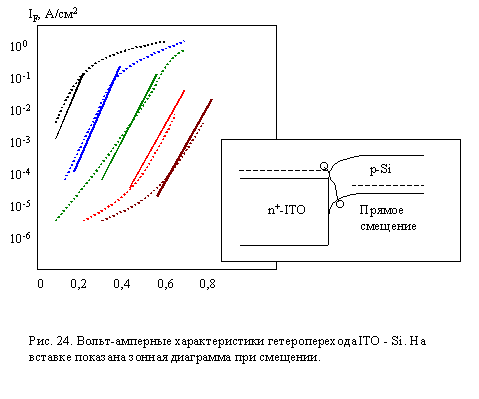
На рис. 24 показана зонная диаграмма солнечного элемента ITO - Si. Верхним слоем служит окисел ITO n-типа. Толщина слоя равна 4000 А
0, а его удельное сопротивление составляет 5*10-4 Ом*см. В качестве подложки выбран кремний p-типа с удельным сопротивлением 2 Ом*см. Все кривые на рис. 24 при плотностях тока порядка 1 мА/см2 параллельны друг другу. Наклон d(lnJ)/dV составляет ~24 В-1 и не зависит от температуры. Такой наклон соответствует многоступенчатому туннелированию внутри гетероперехода. Значения к. п. д. лежат в диапазоне 12 - 15 %. Для солнечных элементов n-ITO/p-InP в условиях AM2 к. п. д. =14 %.Для получения высокой эффективности преобразования был предложен каскадный солнечный элемент с гетеропереходами. Прибор состоит из широкозонного (E
g=1,59) и узкозонного (Eg=0,95 эВ) элементов, последовательно соединенных туннельным диодом на гетеропереходе. Туннельный диод создается во время единого цикла изготовления такой монолитной структуры. Лицевая гетероповерхность, которая служит оптическим окном и позволяет снизить потери от поверхностной рекомбинации. Свет, который проходит первый элемент, не поглощаясь в нем, не поглотится также в сверхтонком туннельном диоде, а приведет к генерации и коллектированию носителей в узкозонном элементе. Оптимизировав соотношение между запрещенными зонами этих двух элементов, можно уравнять значения их работ токов. При этом предельное теоретическое значение к. п. д. в условиях АМ1,5 при комнатной температуре оказывается выше 30 %.