7.2. Солнечные элементы на барьерах Шоттки и МДП - структурах.
На рис. 26 представлена диаграмма энергетических зон освещённого солнечного элемента с барьером Шоттки. При этом слой металла должен быть достаточно тонким, чтобы основная доля света достигла полупроводника. Можно выделить три компоненты фототока. Одна из них обусловлена поглощением в металле фотонов с энергией hn ® qj В (qj В - высота барьера), что вызывает возбуждение дырок через барьер в полупроводник (эта компонента на рис. 26 обозначена цифрой 1). Попадающий в полупроводник коротковолновый свет поглощается главным образом в обеднённом слое (соответствующий фототок на рис. 26 обозначен цифрой 2). Длинноволновый свет, поглощается в нейтральном объёме полупроводника, создаёт электронно-дырочные пары; затем электроны, так же как и в случае обычного р-n - перехода, диффундируют к краю обеднённого слоя, где происходит их коллектирование (этот фототок на рис. 26 обозначен цифрой 3). В условиях, типичных для работы солнечных элементов, возбуждение светом носителей из металла в полупроводник составляет менее 1% полного фототока, и поэтому этим процессом можно пренебречь.
К преимуществам солнечных элементов с барьерами Шоттки относятся: 1) изготовление таких элементов при низких температурах, поскольку отпадает необходимость в проведении высоковольтной операции - диффузии; 2) применение данной технологии при создании поликристаллических и тонкоплёночных солнечных элементов; 3) высокая радиационная стойкость элементов, поскольку вблизи их поверхности существует сильное электрическое поле; 4) большой выходной ток и хороший спектральный отклик, что также обусловлено непосредственным примыканием обеднённого слоя к поверхности полупроводника, вследствие чего ослабляется негативное влияние малых времен жизни и высокой скорости поверхностной рекомбинации.
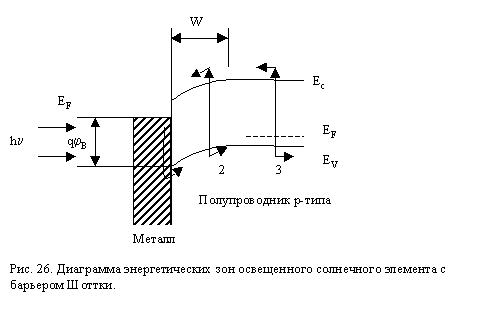
Две основные компоненты спектрального отклика и фототока связаны с генерацией носителей в обедненном слое и в электронейтральной базовой области. Коллектирование носителей в объединённом слое происходит так же, как и в p-n-переходе. Сильное поле в обеднённом слое выносит из него генерируемые светом носители еще до того, как они успевают рекомбинировать, вследствие чего фототок оказывается равным
![]() (41)
(41)
где Т(
l ) - коэффициент пропускания металлом монохроматического света с длиной волны l . Фототок, создаваемый генерацией носителей в базовой области, описывается выражением, идентичным формуле (26), в которой величина (1 - R) должна быть заменена на Т(l ), а a (xi + W) - на a W. Если тыловой контакт является омическим и толщина прибора гораздо больше диффузионной длины H` >> Lp, выражение для фототока базовой области можно упростить и представить в виде![]() . (42)
. (42)
Полный фототок равен сумме выражений (41) и (42). Видно, что для увеличения фототока следует повышать коэффициент пропускания Т и диффузионную длину L
n. Однако его величина при любой заданной энергии фототока оказывается несколько меньше за счет отражения и поглощения света металлической пленкой. Коэффициент пропускания света золотыми пленками (толщиной 10-100 ангстрем) с просветляющим покрытием может достигать 90-95 %.Вольт-амперные характеристики освещенного солнечного элемента с барьером Шоттки имеют вид
![]() , (43)
, (43)
где
![]() , (44)
, (44)
n - фактор идеальности, А - площадь, А
** - эффективная постоянная Ричардсона и qj В - высота барьера. Используя выражение для эффективности (11) и формулы (43) и (44), можно вычислить зависимость к. п. д. от высоты барьера для данного полупроводника. Такие идеальные зависимости (не учитывается отражение света и резистивные потери и предполагается, что фактор идеальности равен 1) приведены на рис 27. Видно, что к. п. д. возрастает с увеличением высоты барьера и в предельном случае qj В (маск) = Еg его максимальное значение составляет ~ 25 %. Показанные на рис. 27 предельные значения к. п. д. для различных полупроводников сравнимы с предельными значениями к. п. д. в случае гомопереходов.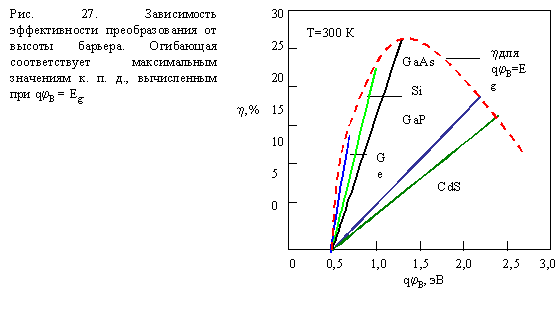
Чтобы получить большую высоту барьера Шоттки, обычно для полупроводников n-типа используют металлы с высокой работой выхода, а для полупроводников р-типа - металлы с низкой работой выхода. Например, для Si р-типа используется двухслойный электрод (слой меди и хрома составляет 50 ангстрем), в котором хром служит для создания барьера Шоттки, а медь используется в качестве защитного покрытия. Для большинства систем металл - полупроводник, создаваемых на однородных подложках, максимальная высота барьера составляет ~ 2/3E
g. Однако отношение высоты барьера к ширине запрещенной зоны может быть увеличено, если между металлом и полупроводниковой подложкой ввести сильнолегированный слой (толщиной 100 ангстрем и с противоположным по отношению к подложке типом легирования). На рис. 28 (вставка) показана зонная диаграмма барьера Шоттки в системе - р+ - n--полупроводник. Тогда эффективная высота барьера равнаqj В= qj m - qc + qVpm, (45)
где q
j m - работа выхода из металла, c - электронное сродство полупроводника, Vpm - высота максимума потенциала в полупроводнике, равная![]() .
.
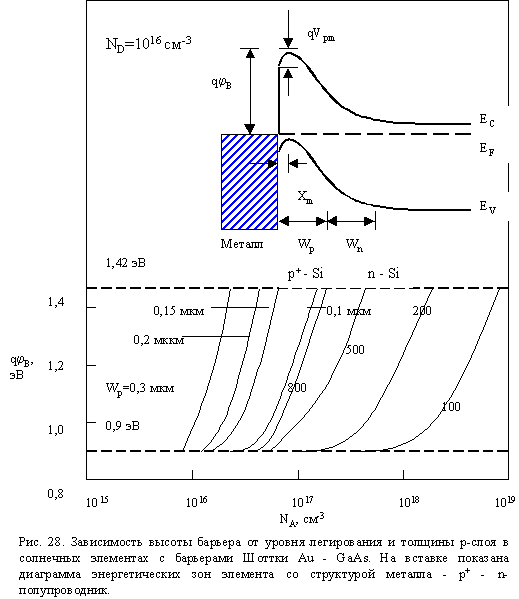
Эти выражения получены в предположении N
aWp>>NDWn, что соответствует полной ионизации тонкого р-слоя и существованию максимума потенциала внутри этого слоя. При перестановке n- и р-слоёв получается комплементарный прибор со структурой металл - n+ - p-полупроводник. На рис. 28 приведены также вычесленные зависимости высоты барьера от NA и Np в GaAs при ND = 1016 см-3. Сильнолегированный приповерхностный слой можно создавать с помощью ионной имплантации и молекулярно-лучевой эпитаксии. Другим методом получения такого слоя будет металлургический. Высота барьера в контакте Al - Si (n-типа) при термообработке (<580 0С) возрастает от 0,68 до 0,9 эВ. При этом образуется тонкий рекристаллизованный р+-слой (~100В солнечных элементах на МДП-структурах между металлом и полупроводниковой подложкой создается тонкий изолирующий слой. Преимущества солнечных элементов на МДП-структурах связано с тем, что в них имеется сильное электрическое поле вблизи поверхности полупроводника, которое направлено так, что помогает коллектированию носителей, создаваемых коротковолновым светом; кроме того, в активной области таких элементов нет кристаллических дефектов, возникающих при диффузии примесей и присущих солнечных элементам с диффузионными р - n-переходами. В туннельных МДП-структурах выражение для плотности тока насыщения отличается от соответствующего выражения для барьера Шоттки дополнительным туннельным множителем
![]() , (47)
, (47)
где q
j T - средняя высота барьера в изолирующем слое (мкм) и d - толщина изолируущего слоя (![]() . (48)
. (48)
Из формулы (48) видно в солнечных элементах на МДП-структурах V
xx растет с увеличением d . В то же время при увеличении толщины диэлектрика d уменьшается ток короткого замыкания, что может приводить к уменьшению эффективности преобразования. Оптимальная толщина диэлектрика в системе металл - SiO2 - Si составляет ~20В рассмотренных выше солнечных элементах на МДП-структурах вся поверхность элемента покрыта очень тонким слоем металла. На рис. 29 показана новая конструкция элемента, в которой используется гребенка в виде МДП-структуры с толстым металлом. Между отдельными полосками полупроводник покрыт прозрачным диэлектрическим слоем. Слой SiO
2 толщиной 1000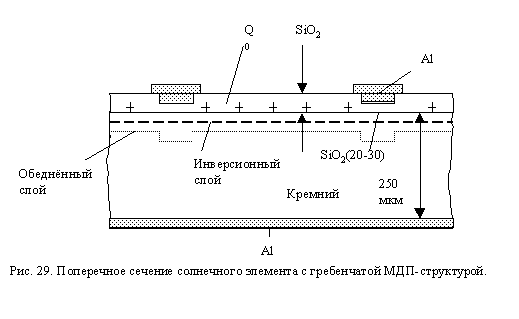
7.3. Тонкопленочные солнечные элементы.
В тонкоплёночных солнечных элементах активными полупроводниковыми слоями являются поликристаллические или неупорядоченные пленки, которые наносятся или выращиваются на электрически активных или пассивных подложках (таких, как стекло, пластмасса, керамика, металл, графит или металлургический кремний). Тонкие плёнки CdS, Si, GaAs, InP, CdTe и т. д. наносятся на подложку с помощью различных методов, таких, как газовая эпитаксия, плазменное распыление и осаждение. Если толщина слоя полупроводника превышает обратный коэффициент поглощения, большая часть генерируемых светом носителей может быть коллектирована.
Основное достоинство тонкоплёночных солнечных элементов заключается в том, что их стоимость может быть низкой, поскольку технология их изготовления дешёвая и при этом используется сравнительно дешёвые материалы. К основным недостаткам относятся низкий к. п. д. и постепенная деградация характеристик. Низкий к. п. д. обусловлен частично влиянием границ зерен, а частично низким качеством полупроводникового материала, выращиваемого на различных подложках. Проблема деградации связана с химическими реакциями, протекающими между полупроводником и окружающей атмосферой (кислородом, парами воды).
Элементы создаваемые с использованием подложек, покрытых электрически осаждённой медью, поверх которой наносится слой цинка толщиной 0,5 мкм. На подложку, подогретую до 220 0С, осаждается слой CdS толщиной 20 мкм. Реакция между плёнкой CdS и ионами меди приводит к образованию слоя Cu2S толщиной 1000 ![]() . Поверх слоя наносится прозрачная контактная гребёнка и слой просветляющего покрытия. На рис. 31 показана энергетическая диаграмма элемента Cu2S - CdS. По существу этот элемент представляет собой гетеропереход с большой плотностью ловушек на границе раздела. При освещении с лицевой стороны излучение поглощается в основном в Cu2S. Спектральный отклик и фототок ограничиваются высокой скоростью поверхностной рекомбинации на границе раздела. Несмотря на это, к. п. д. такого элемента близок к 10%. Кроме того, здесь возможен дальнейший прогресс: ожидается, что при замене от 15 до 25 % цинка кадмием вырастет выходное напряжение и к. п. д. окажется выше 14 %.
. Поверх слоя наносится прозрачная контактная гребёнка и слой просветляющего покрытия. На рис. 31 показана энергетическая диаграмма элемента Cu2S - CdS. По существу этот элемент представляет собой гетеропереход с большой плотностью ловушек на границе раздела. При освещении с лицевой стороны излучение поглощается в основном в Cu2S. Спектральный отклик и фототок ограничиваются высокой скоростью поверхностной рекомбинации на границе раздела. Несмотря на это, к. п. д. такого элемента близок к 10%. Кроме того, здесь возможен дальнейший прогресс: ожидается, что при замене от 15 до 25 % цинка кадмием вырастет выходное напряжение и к. п. д. окажется выше 14 %.
Основой другого тонкоплёночного элемента служит гетеропереход CuInSe2/CdS. Его зонная диаграмма показана на рис. 32 (вставка). Ток короткого замыкания и к. п. д. зависят от размера зёрен. При увеличении радиуса зерна от 0,3 до 1 мкм и выше к. п. д. возрастает от 4 до 6,6 %. В качестве материалов для создания дешёвых солнечных элементов можно рассматривать целый ряд тройных соединений. На рис. 33 представлены некоторые полупроводники групп I - III - VI2 и II - IV - V2, которые пригодны для эффективного фотовольтаического преобразования солнечной энергии.
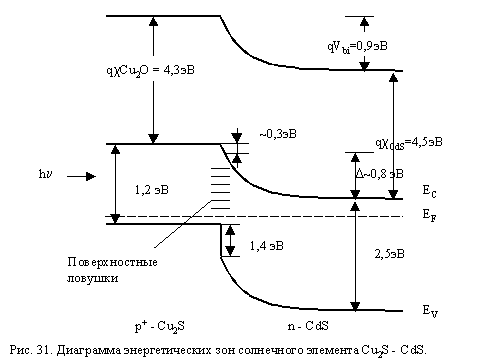
В качестве материала для тонкоплёночных солнечных элементов используются также аморфный кремний (а-Si). Слои толщиной 1-3 мкм выращиваются на стеклянных подложках, покрытых слоем металла или ITO, с помощью разложения силана в высокочастотном разряде. Кристаллический и аморфный кремний сильно различается: первый имеет непрямую запрещённую зону шириной 1,1 эВ, в то время как характеристики оптического поглощения в гидрогенезированном а-Si напоминают характеристики с прямой запрещенной зоной шириной 1,6 эВ (рис. 34). На тонких плёнках гидрогенезированного а-Si были созданы солнечные элементы как с p - n-переходами, так и с барьерами Шоттки. На рис. 35 схематически представлено несколько диаграмм различных структур солнечных элементов на а-Si. Поскольку в видимой части солнечного спектра коэффициент поглощения в а-Si составляет 104 - 105 см-1, большинство носителей генерируется на расстоянии, не превышающем 1 мкм от освещённой поверхности. Диффузионная длина не превышает ~1 мкм, а темновое удельное сопротивление оказывается порядка 100 МОм*см. Отсюда получаем, что в p-i-n-приборе с толщиной i-слоя 1 мкм последовательное сопротивление составляет 104 Ом*см. Поэтому даже наилучшие результаты для элемента с барьером Шоттки (прозрачный металлический слой) относительно невысоки (к.п.д. ~ 6 %).
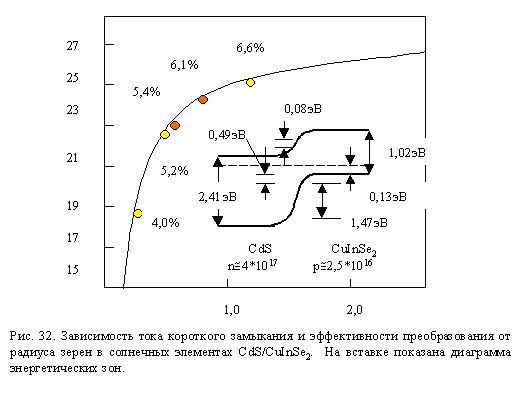

Для проведения оценки предельных возможностей приборов на неупорядоченных тонких плёнках рассмотрим идеализированный тонкоплёночный солнечный элемент (рис. 36). Зонная диаграмма этого элемента в состоянии термодинамического равновесия показана на рис. 36, а. Элемент состоит из слоя полупроводника толщиной L, заключённого между двумя металлическими пластинами электродами с различными работами выхода. Металлы выбраны так, что уровень Ферми в одном из них проходит вблизи края зоны проводимости, а в другом - вблизи края валентной зоны. Один из электродов сделан настолько тонким, что практически не мешает прохождению солнечного излучения. Предполагается, что в прямозонном полупроводнике для фотонов с энергией, превышающей на несколько десятков эВ энергию края поглощения,
a > 105 см-1. Диаграмма на рис. 36, б построена в предположении, что свет поглощается в области сильного электрического поля, вследствие чего происходит эффективное разделение электронов и дырок.
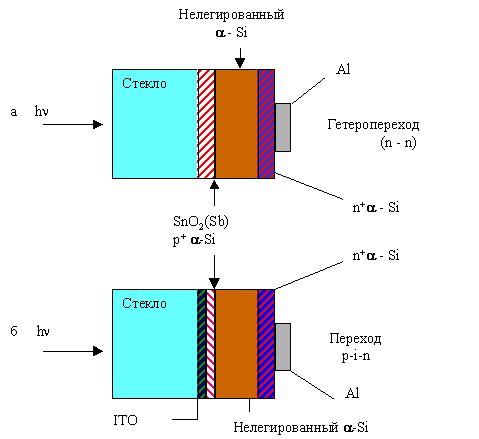
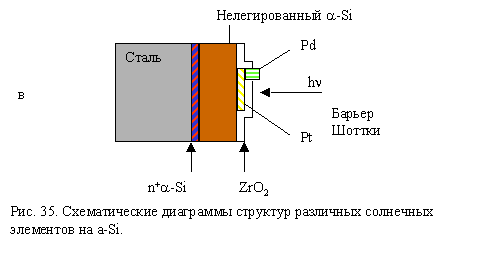

Поскольку в таких полупроводниках концентрация ловушек довольна высока, следует оценить, при какой концентрации ловушек характеристики прибора начнут ухудшаться. В отсутствие заряженных центров электрическое поле, как показано на рис. 36, б, оказывается однородным и равным ![]()
Электрическое поле должно быть настолько большим. Чтобы время пролёта L/
m x , за которое электроны и дырки уходят из полупроводника. Было меньше рекомбинационного времени жизни (ntu s )-1, где s - сечение захвата ~ 10-14 см2 и u - тепловая скорость ~ 107 см/с. Это условие удовлетворяется, если![]() . (49)
. (49)
Выполнение соотношения (49) вполне реально.
Таким образом, из приведённого обсуждения следует, что высокоэффективные солнечные элементы можно создавать из полупроводников с очень высокой плотностью дефектов, если полупроводниковые плёнки достаточно тонкие, имеют коэффициент поглощения вблизи края фундаментального поглощения и в них достигаются требуемые значения подвижности.
Используя зеркала и линзы, можно фокусировать солнечный свет. Оптическое концентрированное излучение представляет собой весьма привлекательный и удобный способ снижения высокой стоимости солнечных элементов, поскольку при этом большая часть площади солнечного элемента заменяется поверхностью концентратора. Кроме того, имеются и другие достоинства: 1) возрастает к. п. д. элемента (см. рис. 7); 2) появляется возможность создания гибридных систем, которые одновременно вырабатывают электрическую энергию и тепло; 3) ослабляется зависимость эффективности работы элемента от температуры окружающей среды.
На рис. 37, а показана стандартная плоско-выпуклая линза, а на рис. 37, б - эквивалентная её линза Френеля. В концентрирующем модуле, обеспечиваем 500-1000-кратную концентрацию солнечного света (рис. 37, в), солнечный свет, отражённый первым зеркалом, попадает на второе зеркало, которое фокусирует его на солнечном элементе, в блоке с водяным охлаждением. Экспериментальные результаты, полученные с помощью кремниевого солнечного элемента с вертикальными переходами (рис. 21), смонтированного в концентраторе (рис. 37, в), приведены на рис. 38. Видно, что рабочие характеристики прибора улучшаются при увеличении интенсивности излучения от от эквивалентной 1 солнцу до интенсивности, эквивалентной 1000 солнц. Ток короткого замыкания возрастает линейно с увеличением концентрации излучения. Напряжение холостого хода возрастает на 0,1 В при увеличении излучения в 10 раз, в то время как фактор заполнения изменяется слабо. Коэффициент полезного действия элемента, который является произведением трёх указанных выше величин, делённым на мощность излучения, падающего концентратор, возрастает на ~ 2 % при увеличении концентрации излучения в 10 раз. Считается, что при использовании соответствующих просветляющих покрытий к. п. д. может составлять ~ 22 % при интенсивности излучения, равной интенсивности 1000 солнц. Поэтому один элемент, освещаемый 1000-кратной концентрацией солнечного элемента излучения, обеспечивает выходную мощность, равную мощности 1300 элементов, освещаемых светом одного солнца. Следовательно, метод концентрации света обеспечивает возможность замены дорогостоящих солнечных элементов сравнительно дешёвыми материалами концентратора, и его можно реализовать с помощью относительно простого устройства, что позволяет минимизировать стоимость всей системы.
При сильном концентрировании излучения концентрация неравновесных носителей становиться сравнимой по порядку величины с концентрацией легирующей примеси в подложке, и таким образом реализуется условие высокого уровня инжекции. При этом плотность тока пропорциональна exp(qV/nkT) с n = 2. Напряжение холостого хода равняется
![]() . (50)
. (50)
Величину J
s можно представить в виде![]() , (51)
, (51)
где Т - рабочая температура, Т
0 = 300 К. Температурная зависимость Vxx при различных уровнях концентрирования приведена на рис. 39. Температурный коэффициент изменения Vxx уменьшается по абсолютной величине от - 2,07 мВ/0С при солнечном излучении до -1,45 мВ/0С при 500-кратной концентрации солнечного излучения. Таким образом, для кремниевых солнечных элементов высокие уровни концентрирования солнечного излучения снижают эффективность потерь, обусловленных работой элемента при повышенных температурах.
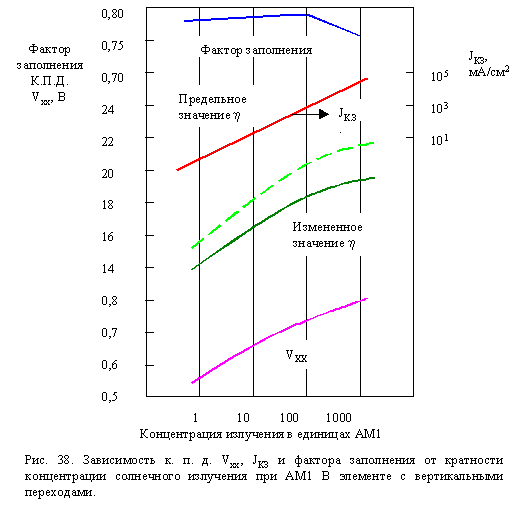
При концентрировании излучения хорошие рабочие характеристики могут иметь и солнечные элементы на GaAs с лицевой гетероповерхностью. На рис. 40 приведена вольт-амперная характеристика этого элемента при интенсивности излучения, эквивалентной излучению 945 солнц в условиях АМ1,5. Фактор заполнения этого прибора равен 0, 79, наприжение холостого хода составляет 1,13 В, максимальная выходная мощность 10,7 Вт и к. п. д. 23,3 % при 50 С.

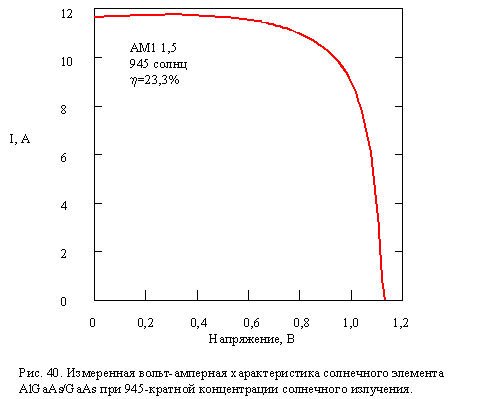
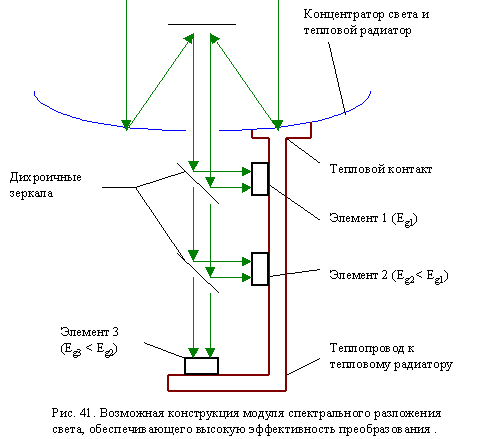
Для повышения к. п. д. и выходной мощности можно использовать многокаскадные солнечные элементы (рис. 8 и 25) либо устройства спектрального разложения света. В последнем случае солнецное излучение разлагается на много узких спектральных полос и излучение из каждой полосы преобразуется с помощью элемента, ширина запрещенной зоны которого выбрана наиболее оптимальной по отношению к спектральному составу данной полосы. Возможная конструкция устройства спектрального разложения света показана на рис 41. Дихроичные зеркала разлагают падающий свет, отражая фотоны с высокой энергией в элемент 1 и пропуская фотоны с низкой энергией к элементу 2 и далее к элементу 3. При 1000-кратном концентрировании солнечного излучения максимальное значение к. п. д. при деление света на два спектральных диапазона можно получить с помощью описываемого выше (рис. 8) графического метода. Это значение составляет ~60 %. При делении излучения на 3 спектральные полосы максимум к. п. д. близок к 70 %, а при делении на 10 полос он составляет ~85 %. Идеальное значение к. п. д. при разложение света на n спектральных полос выше, чем при последовательном соединение n каскадов с различными ширинами запрещенной зоны. Дело в том, что при разложении спектра плотность тока в каждом элементе оптимитизируется независимо. Это обеспечивает максимум к. п. д. всей системы.
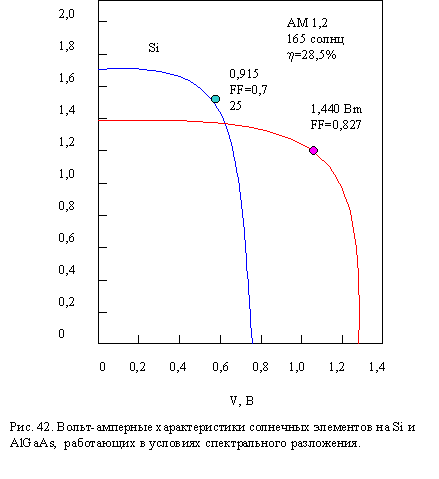

На рис. 42 показано экспериментально реализованное устройство, состоящее из солнечного элемента Al
xGa1-xAs c х< 0,24, кремниевого солнечного элемента и фильтра, осуществляющего разложение спектра. На этом же рисунке приведены вольт-амперные характеристики обоих элементов при 165-кратной концентрации солнечного излучения (АМ1,2). Максимальная выходная мощность составляет 1,44 Вт и 0,95 Вт для элементов на AlGaAs (Eg=1,61 эВ) и Si (Eg=1,1 эВ) соответственно, а значения к. п. д. равны 17,4 и 11,1 %. Полный к. п. д. системы равен 28,5 % при 30 0С.Другой перспективный метод преобразования солнечной энергии состоит в использование листа стекла или пластмассы, покрытого люминесцирующими красителями, которые поглощают солнечный свет в узких спектральных диапазонах, а затем испускают фотоны разных энергий во многих направлениях (рис. 43). Свет, отражаемый от границ, оказывается "захваченным" внутри листа, поскольку красители уже не могут поглощать его и он в
конце концов попадает к краю листа, где расположен солнечный элемент. Для такой системы не нужно устройство слежения за Солнцем, поскольку красители поглощают свет, падающий под любым углом. Теоретическое значение к. п. д. здесь превышает 50 %.