Рентгеноструктурный анализ аморфных материалов
3.2. Введение поправок на поляризацию излучения и поглощение в образце
В значения интенсивности I о(К), полученные после вычитания рассеяния воздухом и с. ф. из I изм(К), необходимо ввести поправки на поляризацию, которые зависят от геометрии получения дифракционной картины.
Рентгеновское излучение при рассеянии веществом частично поляризуется, вследствие чего ослабляется его интенсивность [2] . Необходимо найти интенсивность, которая наблюдалась бы при отсутствии поляризации.
В экваториальной геометрии исследований при установке кристалла-монохроматор в па-дающих лучах, поляризационный фактор имеет вид:
 (3.4)
(3.4)
Здесь α 1 - брэгговский угол для монохроматора КМ1 (рис.10).
Монхроматизация только отраженных лучей при той же геометрии получения дифракционной картины приводит к поляризационному фактору вида
 (3.5)
(3.5)
α 1 - брэгговский угол для монохроматора КМ2 (рис.10).
Для случая двойной монохроматизации
 (3.6)
(3.6)
Фактор поглощения А(2θ) зависит от геометрии исследований, а также формы и тол-щины образца. Для тонких плоскопараллельных образцов, исследуемых а) в геометрии на отражение в симметричном случае,
 (3.7)
(3.7)
б) в геометрии на прохождение в симметричном случае,
 (3.8)
(3.8)
При рентгенографировании бесконечно толстого образца в симметричной установке поправка на поглощение не зависит от угла рассеяния:
 (3.9)
(3.9)
Необходимость в асимметричной установке образца на дифрактометре возникает в двух ситуациях: во-первых, при проверке исследуемого образца на изотропность и, во-вторых, при изучении тонких пленок, то есть объектов, толщина которых значительно меньше оптимальной.
Фактор поглощения для асимметричной съемки на прохождение имеет вид :
 (3.10)
(3.10)
Через α обозначен угол между падающим пучком и поверхностью кристалла.
Для геометрии на отражение при асимметричной установке образца
 (3.11)
(3.11)
Здесь α - угол между падающим лучом и поверхностью образца :
β=2θ-α.
В работе [21 ] рассматривается дифрактометр для исследования тонкопленочных материалов, позволяющий резко повысить контрастность рентгенограммы. Принципиальная схема показана на рис.11.

Рис.11. Принципиальная схема рентгеновского дифрактометра для исследования тонкопленочных материалов:
F - фокус трубки; С 1 - щель Соллера, предназначенная для ограничения вертикальной расходимости; О - образец; С 2 . - щель Соллера, предназначенная для ограничения горизонтальной расходимости; КМ- монохроматор; Сч - счетчик [21 ]
Образец устанавливается под фиксированным углом α по отношению к первичному лучу. Использование щелей Соллера обеспечивает высокое угловое разрешение, а постоянство угла α приводит к тому, что при 2ν >10° поправка на поглощение не зависит от угла рассеяния и интенсивность дифрагированных лучей оказывается тем выше, чем меньше угол α .
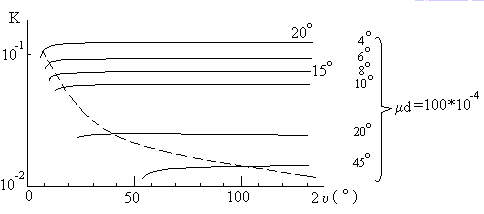
Рис.12. Зависимость геометрической части коэффициента поглощения A’=μ m ρA от угла рассеяния; μd = 100 •10-4 . Сплошные линии - расчеты для асимметричной установки образца на гониометре; пунктирная - для симметричной геометрии ν - 2ν [ 21].
На рис.12 приведены зависимости коэффициента A’(2θ)=μ m ρdA(2θ) для материала с μ m ρd=μd = 100 •10-4 от угла рассеяния 2θ - при различных значениях α. Для α = 4° величина А ’ при 2θ ≈ 130o на порядок выше, чем для случая геометрии θ ÷ 2θ.
Кроме того, преимущество рассматриваемой геометрии съемки заключаются еще и в том, что при исследовании пленок, осажденных или полученных на монокристаллических подложках, отражения от подложки исчезают.
На рис.13 приведена картина дифракции пленкой Au (d=100 Ao ), напыленной на монокристалл Si , полученная в асимметричной (а) и симметричной (б) геометриях.
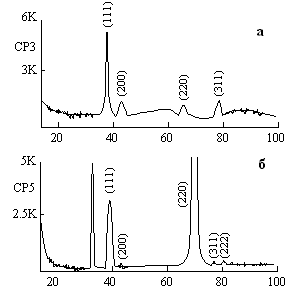
Рис.13. Дифракционная картина от пленки золота (d = 100 Ao ), напыленной на монокристалл Si;
а - асимметричная геометрия; б- симметричное θ ÷ 2θ сканирование [21] .
Исправленная на с.ф., рассеяние воздухом, поглощение и поляризацию интенсивность записывается как
 (3.12)
(3.12)
Если исследуемые образцы представляют собой тонкие, неотделенные от подложки пленки, то I изм (K ) включает в себя не только рассеяние воздухом, но и рассеяние подложкой. Для таких объектов
 (3.13)
(3.13)
Распределение интенсивности рассеяния подложкой измеряется до получения на ней пленки (или после отравливания пленки) исправляется на с.ф. и рассеяние воздухом и обозначается In (К).
Полученная после введения всех поправок интенсивность In (К) представляет собой сумму когерентного и некогерентного (комптоновского) рассеяния, выраженную в относительных единицах, чаще всего в имп/с; при расчетах же кривых распределения электродной или атомной плотности и кривых D(r ) используются значения I (К) /N интенсивности в абсолютных единицах на атом или на единицу состава. Разработан целый ряд методов приведения Io (К) к абсолютным единицам. Однако, прежде чем переходить к рассмотрению методов расчета коэффициента нормировки, необходимо остановиться на влиянии качества подготовки поверхности образца на дифракционную картину.
Эффект нарушения соотношения интенсивностей брэгговских отражений в поликристаллах, обусловленный рельефом поверхности образца, называют микропоглощением [22].
В сильно поглощающих образцах наличие рельефа на поверхности приводит к резкому ослаблению интенсивностей отражений, наблюдавшихся в области углов 20-40o ( в 2θ ).
В аморфных порошковых образцах был обнаружен аналогичный эффект (рис.14).
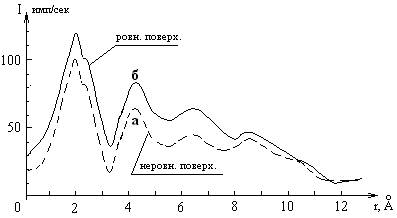
Рис.14. Кривые распределения интенсивности рассеяния образцами W О 3 ; а - имеющими шероховатую поверхность; б - имеющую ровную поверхность .
Таким образом, для получения достоверных данных необходима тщательная подготовка поверхности образца: рельеф поверхности должен удовлетворять условию μ h ≤ 0.05. Здесь h - высота неровности; μ - линейный коэффициент поглощения .