Обогащение (Ys<0).
.
При обогащении поверхности дырками, как основными носителями поверхностный потенциал Ys зависит от напряжения на затворе VG логарифмически, а заряд Qsc в ОПЗ зависит от напряжения на затворе VG линейно.
Рассмотрим более подробно связь между напряжением на затворе VG МДП структуры и поверхностным потенциалом Ys. Все приложенное напряжение VG к МДП структуре делится между диэлектриком и полупроводником, причем очевидно, что падение напряжения в полупроводнике равняется поверхностному потенциалу Ys. Таким образом,
VG =Vox+Ys (1).
Из (1) и анализа зонных энергетических диаграмм на рисунке следует, что знак поверхностного потенциала Ys, выбранный нами ранее a priori, в действительности соответствует знаку напряжения на затворе VG. Действительно, положительное напряжение на затворе идеальной МДП структуры вызывает изгиб зон вниз у полупроводников n и p-тирпа, что соответствует положительным значениям поверхностного потенциала. Отрицательное напряжение VG вызывает изгиб зон вверх у поверхности полупроводника, что соответствует отрицательному значению поверхностного потенциала Ys.
Из условия электронейтральности следует, что заряд на металлическом
электроде Qm должен быть равным суммарному заряду в ОПЗ Qsc , заряду поверхностных
состояний на границе раздепа полупроводник-диэлектрик Q
ss и встроенному заряду в диэлектрик вблизи границы раздела Qox. Тогда
-Qm=Qss+Qsc+ Qox.
Согласно определению геометрической емкости Co
Cox=Qm/Vox,
отсюда Vox=-Qss/Cox - Qsc/Cox - Qox/Cox.
Учитывая, что между металлом и полупроводником существует разность термодинамических
работ DYms, получаем
VG= -DYms - Qox/Cox+qNssY0/Cox+Ys-Qss/Cox+qNssYs/Cox (2).
Введем новое обозначение - напряжение плоских зон Vfb (flat band).
Напряжением плоских зон Vfb называется напряжение на затворе реальной МДП
структуры, соответствующее значению поверхностного потенциала, равного
нулю Vfb=VG(Ys=0) (3).
С учетом определения (2) из (3) следует
Vfb =DYms - Qox/Cox+qNssY0/Cox (4).
Таким образом связь между напряжением на затворе VG и поверхностным
потенциалом Ys с учетом (4) задается в виде
VG=Vfb+Ys+qNssYs/Cox- Qsc/Cox (5).
Проведем более подробный анализ (5) для различных областей изменения
поверхностного потенциала (Ys).
Обогащение (Ys<0).
.![]()
При обогащении поверхности дырками, как основными носителями поверхностный
потенциал Ys зависит от напряжения на затворе VG логарифмически, а заряд
Qsc в ОПЗ зависит от напряжения на затворе VG линейно.
Обеднение и слабая инверсия (0<Ys<2j0 ).
Заряд в ОПЗ Qsc в этом случае в основном обусловлен ионизованными
акцепторами QB.
VG -Vfb=nYs (6),
где n=1+qNss/Cox +CB*/Cox.
Здесь QB*, CB*- величина заряда и емкости ионизованных акцепторов в
ОПЗ при Ys=y0.
Из соотношения (6) следует, что в области обеднения и слабой
инверсии поверхностный потенциал
зависит от напряжения VG линейно, причем tga=dVG/dYs=n определяется
плотностью поверхностных состояний N
ss, толщиной подзатворного диэлектрика d0x и уровнем легирования
полупроводниковой подложки NA.
Сильная инверсия (Ys>2j0).
Заряд в ОПЗ Qsc отрицателен, состоит из заряда ионизованных акцепторов
QB и электронов Qn в инверсионном слое.
Введем пороговое напряжение Vt как напряжение на затворе VG,
когда в равновесных условиях поверхностный потенциал Ys равен пороговому
значению 2j0.
.![]()
Vt=Vfb+2j0- QB/Cox+2qNssjo/Cox (7).
Из (7) следует, что если отсчитывать пороговое напряжение VT от напряжения плоских зон Vfb, то оно будет состоять из падения напряжения в полупроводнике 2j0 и падения напряжения на подзатворном диэлектрике за счет заряда ионизованных акцепторов и заряда в поверхностных состояниях. Для достаточно высоких значений Ys, когда bDYs>1, имеем

Из (8) и (9) следует, что в области сильной инверсии, так же как и в области обогащения, поверхностный потенциал логарифмически зависит от напряжения на затворе VG, а заряд электронов в инверсионном слое Qn линейно зависит от величины VG.
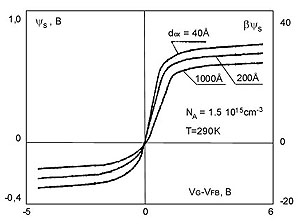
На рисунке приведена зависимость поверхностного потенциала Ys от напряжения
на затворе VG, рассчитанная для различных толщин подзатворного диэлектрика
dox.