ДЕФЕКТЫ И ДИСЛОКАЦИИ
Дефекты дислокации:- Точечные дефекты
Из жидкого расплава можно вырастить монокристалл. Их обычно используют в лабораториях для изучения свойств того или иного вещества. Металлы и сплавы, полученные в обычных условиях, состоят из большого количества кристаллов, то есть, имеют поликристаллическое строение. Эти кристаллы называются зернами. Они имеют неправильную форму и различно ориентированы в пространстве.
Каждое зерно имеет свою ориентировку кристаллической решетки, отличную от ориентировки соседних зерен, вследствие чего свойства реальных металлов усредняются, и явления анизотропии не наблюдается.
В кристаллической решетке реальных металлов имеются различные дефекты (несовершенства), которые нарушают связи между атомами и оказывают влияние на свойства металлов.
Различают следующие структурные несовершенства:
- точечные – малые во всех трех измерениях;
- линейные – малые в двух измерениях и сколь угодно протяженные в третьем;
- поверхностные – малые в одном измерении.
Точеные дефекты
Одним из распространенных несовершенств кристаллического строения является наличие точечных дефектов: вакансий, дислоцированных атомов и примесей. (рис.1).

Рис.1 Точечные дефекты
Вакансия – отсутствие атомов в узлах кристаллической решетки, «дырки», которые образовались в результате различных причин. Образуется при переходе атомов с поверхности в окружающую среду или из узлов решетки на поверхность (границы зерен, пустоты, трещины и т. д. ), в результате пластической деформации, при бомбардировке тела атомами или частицами высоких энергий (облучение в циклотроне или нейтронной облучение в ядерном реакторе). Концентрация вакансий в значительной степени определяется температурой тела. Перемещаясь по кристаллу, одиночные вакансии могут встречаться. И объединяться в дивакансии. Скопление многих вакансий может привести к образованию пор и пустот.
Дислоцированный атом – это атом, вышедший из узла решетки и занявший место в междоузлие. Концентрация дислоцированных атомов значительно меньше, чем вакансий, так как для их образования требуются существенные затраты энергии. При этом на месте переместившегося атома образуется вакансия.
Примесные атомы всегда присутствуют в металле, так как практически невозможно выплавить химически чистый металл. Они могут иметь размеры больше или меньше размеров основных атомов и располагаются в узлах решетки или междоузлиях.
Точечные дефекты вызывают незначительные искажения решетки, что может привести к изменению свойств тела (электропроводность, магнитные свойства), их наличие способствует процессам диффузии и протеканию фазовых превращений в твердом состоянии. При перемещении по материалу дефекты могут взаимодействовать.
Линейные дефекты
Основными линейными дефектами являются дислокации. Априорное представление о дислокациях впервые использовано в 1934 году Орованом и Тейлером при исследовании пластической деформации кристаллических материалов, для объяснения большой разницы между практической и теоретической прочностью металла.
Дислокация – это дефекты кристаллического строения, представляющие собой линии, вдоль и вблизи которых нарушено характерное для кристалла правильное расположение атомных плоскостей.
Простейшие виды дислокаций – краевые и винтовые.
Краевая дислокация представляет собой линию, вдоль которой обрывается внутри кристалла край “лишней“ полуплоскости (рис. 2).

Рис.2 Краевая дислокация (а) и механизм ее образования (б)
Неполная плоскость называется экстраплоскостью.
Большинство дислокаций образуются путем сдвигового механизма. Ее образование можно описать при помощи следующей операции. Надрезать кристалл по плоскости АВСD, сдвинуть нижнюю часть относительно верхней на один период решетки в направлении, перпендикулярном АВ, а затем вновь сблизить атомы на краях разреза внизу.
Наибольшие искажения в расположении атомов в кристалле имеют место вблизи нижнего края экстраплоскости. Вправо и влево от края экстраплоскости эти искажения малы (несколько периодов решетки), а вдоль края экстраплоскости искажения простираются через весь кристалл и могут быть очень велики (тысячи периодов решетки) (рис. 3).
Если экстраплоскость находится в верхней части кристалла, то краевая дислокация – положительная
( ), если в нижней, то – отрицательная (
), если в нижней, то – отрицательная ( ).
Дислокации одного знака отталкиваются, а противоположные притягиваются.
).
Дислокации одного знака отталкиваются, а противоположные притягиваются.

Рис. 3. Искажения в кристаллической решетке при наличии краевой дислокации
Другой тип дислокаций был описан Бюргерсом, и получил название винтовая дислокация.
Винтовая дислокация получена при помощи частичного сдвига по плоскости Q вокруг линии EF (рис. 4). На поверхности кристалла образуется ступенька, проходящая от точки Е до края кристалла. Такой частичный сдвиг нарушает параллельность атомных слоев, кристалл превращается в одну атомную плоскость, закрученную по винту в виде полого геликоида вокруг линии EF, которая представляет границу, отделяющую часть плоскости скольжения, где сдвиг уже произошел, от части, где сдвиг не начинался. Вдоль линии EF наблюдается макроскопический характер области несовершенства, в других направлениях ее размеры составляют несколько периодов.
Если переход от верхних горизонтов к нижним осуществляется поворотом по часовой стрелке, то дислокация правая , а если поворотом против часовой стрелки – левая.

Рис.4. Механизм образования винтовой дислокации
Винтовая дислокация не связана с какой-либо плоскостью скольжения, она может перемещаться по любой плоскости, проходящей через линию дислокации. Вакансии и дислоцированные атомы к винтовой дислокации не стекают.
В процессе кристаллизации атомы вещества, выпадающие из пара или раствора, легко присоединяются к ступеньке, что приводит к спиральному механизму роста кристалла.
Линии дислокаций не могут обрываться внутри кристалла, они должны либо быть замкнутыми, образуя петлю, либо разветвляться на несколько дислокаций, либо выходить на поверхность кристалла. Дислокационная структура материала характеризуется плотностью дислокаций.
Плотность дислокаций в кристалле определяется как среднее число линий дислокаций, пересекающих внутри тела площадку площадью 1  , или как суммарная длина линий дислокаций в объеме 1
, или как суммарная длина линий дислокаций в объеме 1  .
.
 (
( ,
,  )
)Плотность дислокаций изменяется в широких пределах и зависит от состояния материала. После тщательного отжига плотность дислокаций составляет
 , в кристаллах с сильно деформированной кристаллической решеткой плотность дислокаций достигает
, в кристаллах с сильно деформированной кристаллической решеткой плотность дислокаций достигает
 .
Плотность дислокации в значительной мере определяет пластичность и прочность материала (рис. 5).
.
Плотность дислокации в значительной мере определяет пластичность и прочность материала (рис. 5).
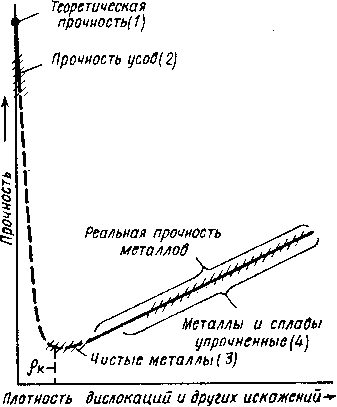
Рис.5. Влияние плотности дислокаций на прочность
Минимальная прочность определяется критической плотностью дислокаций
 .
.Если плотность меньше значения а, то сопротивление деформированию резко возрастает, а прочность приближается к теоретической.
Повышение прочности достигается созданием металла с бездефектной структурой, а также повышением плотности дислокаций, затрудняющим их движение.
В настоящее время созданы кристаллы без дефектов – нитевидные кристаллы длиной до 2 мм, толщиной 0,5…20 мкм - “усы“ с прочностью, близкой к теоретической: для железа
 = 13000 МПа, для меди
= 13000 МПа, для меди  =30000 МПа.
При упрочнении металлов увеличением плотности дислокаций, она не должна превышать значений
=30000 МПа.
При упрочнении металлов увеличением плотности дислокаций, она не должна превышать значений  .
В противном случае образуются трещины.
.
В противном случае образуются трещины.
Дислокации влияют не только на прочность и пластичность, но и на другие свойства кристаллов. С увеличением плотности дислокаций возрастает внутреннее, изменяются оптические свойства, повышается электросопротивление металла. Дислокации увеличивают среднюю скорость диффузии в кристалле, ускоряют старение и другие процессы, уменьшают химическую стойкость, поэтому в результате обработки поверхности кристалла специальными веществами в местах выхода дислокаций образуются ямки.
Дислокации образуются при образовании кристаллов из расплава или газообразной фазы, при срастании блоков с малыми углами разориентировки. При перемещении вакансий внутри кристалла, они концентрируются, образуя полости в виде дисков. Если такие диски велики, то энергетически выгодно “захлопывание” их с образованием по краю диска краевой дислокации. Образуются дислокации при деформации, в процессе кристаллизации, при термической обработке.
Поверхностные дефекты – границы зерен, фрагментов и блоков (рис. 6).
Рис. 6. Разориентация зерен и блоков в металле
Размеры зерен составляют до 1000 мкм. Углы разориентации составляют до нескольких десятков градусов ( ).
).
Граница между зернами представляет собой тонкую в 5 – 10 атомных диаметров поверхностную зону с максимальным нарушением порядка в расположении атомов.
Строение переходного слоя способствует скоплению в нем дислокаций. На границах зерен повышена концентрация примесей, которые понижают поверхностную энергию.
Однако и внутри зерна никогда не наблюдается идеального строения кристаллической решетки.
Имеются участки, разориентированные один относительно другого на несколько градусов ( ).
Эти участки называются фрагментами. Процесс деления зерен на фрагменты называется фрагментацией или полигонизацией.
).
Эти участки называются фрагментами. Процесс деления зерен на фрагменты называется фрагментацией или полигонизацией.
В свою очередь каждый фрагмент состоит из блоков, размерами менее 10 мкм, разориентированных на угол менее одного градуса
( ). Такую структуру называют блочной или мозаичной.
). Такую структуру называют блочной или мозаичной.
ОПТИЧЕСКИЕ МЕТОДЫ
Большинство методов экспериментального наблюдения дислокаций основано на регистрации напряжений или искажений в решетке, обусловленных дислокацией.
Метод избирательного травления.
Избирательное травление – обработка поверхности кристалла специально подобранным химическим реактивом, в результате действия которого на поверхности образуются мелкие ямки (или бугорки), называемые фигурами травления.
Огранка фигуры травления зависит от симметрии грани кристалла. Фигуры травления образуются в тех местах, где на поверхности кристалла выходит дислокация и, значит, структура кристалла нарушена.
Расположение и число фигур травления характеризуют дислокационную структуру кристалла (рис.7).
По числу ямок травления на  площади определяют плотность дислокаций.
площади определяют плотность дислокаций.

Рис. 7. Ряды фигур травления вдоль малоугловых границ в кристалле сурьмы.
Увеличение 600х
Соответствие каждой фигуры травления месту выхода дислокации может быть показана с помощью одного из следующих методов.
Послойное травление. Протравленную поверхность кристалла с образовавшимися на ней фигурами травления фотографируют и после этого сполировывают с нее тонкий слой так, чтобы при этом не нарушалась дислокационная структура поверхности. Механическая полировка здесь непригодна, потому что при механической шлифовке или полировке создаются новые дислокации; применять можно лишь химическую или ионную полировку. После полировки производят повторное травление той же поверхности тем же травителем и сравнивают полученную картинку с предыдущей. Так как дислокация – линейный дефект, протяженный в глубь кристалла, то новые фигуры травления должны оказаться практически на тех же местах, где они были раньше, если они действительно отвечают выходам дислокаций. Если же фигуры травления соответствуют не дислокациям, а поверхностным или каким-либо другим дефектам, то новое расположение фигур травления не повторяет старое.
Метод сравнения парных поверхностей раскола по спайности. Если расколоть кристалл по плоскости спайности и протравить две парные поверхности раскола, то дислокации, пересекающие поверхность раскола, должны дать зеркально-симметричную картину соответствующих фигур травления, что и наблюдается в действительности (рис. 8). Метод сравнения парных граней очень удобен для регистрации изменения дислокационной структуры кристалла в результате каких-либо внешних воздействий. Например, раскалывая кристалл по спайности, подвергают затем одну из полученных половинок кристалла пластической деформации и сравнивают распределение дислокаций на деформированной и недеформированной половинах образца.


Увеличение 300х
По фигурам травления можно наблюдать за движением дислокаций. Протравим поверхность кристалла и найдем на ней фигуры травления.
Затем подвергнем кристалл действию внешнего напряжения.
В результате дислокация сдвинется со своего места. Вторично протравим прежним травителем ту же грань кристалла. Так как на ее поверхности уже имелись ямки травления, они будут растворяться интенсивнее, чем окружающие их участки.
Однако теперь в этом месте нет выхода дислокации, поэтому ямка травления будет увеличиваться не вглубь, а только вширь. На месте прежней фигуры травления образуется расширившаяся, но неглубокая фигура травления.
В отличие от нее на том месте, где теперь выходит дислокация, образуется новая ямка травления, которую по виду легко отличить от старой: новая фигура травления мельче, но глубже тех, которые возникли на месте старых.
Таким образом, при повторном травлении видны плоские большие фигуры в тех местах, где дислокация была, но теперь оттуда ушла, и мелкие остроконечные фигуры в тех местах, где дислокация теперь выходит на поверхность кристалла, т.е куда она перешла (рис. 9).
Сравнение старых и новых фигур травления по их положениям на грани кристалла позволяет проследить путь, пройденный дислокацией, а одновременное измерение длительности процесса позволяет определить скорость перемещения дислокаций (рис. 9, 10).
Так, на рис. 11 показано расширение дислокационной петли в кристалле KBr, которое произошло под действием мгновенной нагрузки 7 Мпа в течении
 c.
c.

Рис. 9 Схема формирования фигур травления на последовательных этапах (1-4).
Движение краевой дислокации: а - вид сбоку, б – сверху


Рис. 10 Фигуры травления на грани (100) кристалла LIF, иллюстрирующие движение дислокаций. Увеличение 300х

Рис. 11 Движение дислакацоинной петли в кристалле KBr; а- фотография фигур травления, б-схема. Стрелками показано направление перемещения дислокаций.
По фигурам травления можно наглядно проследить за образованием и движением дислокаций в процессе пластической деформации. На рис.12 видна «звезда фигур травления» на грани (100) кристалла фтористого лития, образовавшаяся около того места, где на грань кристалла действовала сосредоточенная нагрузка. В центре звезды виден темный ромбик – отпечаток четырехугольной алмазной пирамиды, вдавившейся в кристалл и создавшей пластическую деформацию. В пластически деформационной области создалось множество дислокаций, движущихся по плоскостям скольжения.

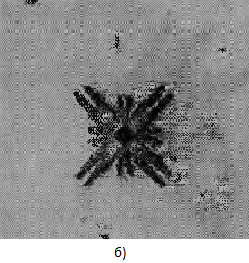
Рис. 12 Звезда фигур травления на грани (001) кристалла LIF: необлученного (а) и облученного (б).Увеличение 300х
В кристаллах фтористого лития, как и во всех кубических кристаллах со структурной каменной соли, система скольжения {110} <110>.
Плоскостей скольжения {110} имеется 12, а на грани куба (100) выходит шесть таких плоскостей: две нормально к грани, а четыре, пересекающиеся друг с другом, - по углом
 .
Скопление дислокаций в этих плоскостях скольжения выявляются в виде рядов фигур травления, образующих звезду.
Длинные, параллельные <100> лучи этой звезды отвечают скоплениям краевых дислокаций, короткие, диагональные – винтовым дислокациям.
Форма и ориентировка звезды не зависят ни от формы, ни от ориентировки вдавливавшейся пирамиды, а только от ориентировки плоскостей скольжения в кристалле.
Длина лучей звезды фигур травления – характерный параметр вещества, по которому можно судить о подвижности дислокаций, а следовательно, и о пластичности кристалла.
Если кристалл упрочнен введенной в него при росте примесью или если в нем под действием облучения возникли радиационные точечные дефекты, то при той же нагрузке образуется звезда с более коротким лучами.
Это значит, что примесные или радиационные точечные дефекты, взаимодействую с полем напряжений дислокации, уменьшают ее подвижность.
По размеру звезды фигур травления можно судить о пластичности и прочности кристалла и о влиянии точечных дефектов на движение дислокаций.
.
Скопление дислокаций в этих плоскостях скольжения выявляются в виде рядов фигур травления, образующих звезду.
Длинные, параллельные <100> лучи этой звезды отвечают скоплениям краевых дислокаций, короткие, диагональные – винтовым дислокациям.
Форма и ориентировка звезды не зависят ни от формы, ни от ориентировки вдавливавшейся пирамиды, а только от ориентировки плоскостей скольжения в кристалле.
Длина лучей звезды фигур травления – характерный параметр вещества, по которому можно судить о подвижности дислокаций, а следовательно, и о пластичности кристалла.
Если кристалл упрочнен введенной в него при росте примесью или если в нем под действием облучения возникли радиационные точечные дефекты, то при той же нагрузке образуется звезда с более коротким лучами.
Это значит, что примесные или радиационные точечные дефекты, взаимодействую с полем напряжений дислокации, уменьшают ее подвижность.
По размеру звезды фигур травления можно судить о пластичности и прочности кристалла и о влиянии точечных дефектов на движение дислокаций.
Определения плотности дислокаций по фигурам травления является основным промышленным методом контроля качества кристалла,
но этот метод применим лишь для кристаллов с плотностью дислокаций, меньшей чем ( -
-  )
)
 . При большей плотности дислокаций уже не удается различать отдельные фигуры травления, они все сливаются друг с другом.
. При большей плотности дислокаций уже не удается различать отдельные фигуры травления, они все сливаются друг с другом.
Еще более нагляден, но и более сложен по технике эксперимента метод декорирования, в котором дислокации делаются видимыми, потому что на них осаждаются чужеродные частицы (см. рис.13). Так, если кристалл кремня подвергнуть отжигу в парах золота, то частицы золота осаждаются вдоль дислокационных стенок, делая их видимыми. В отличие от метода травления метод декорирования позволяет наблюдать дислокационную структуру не только на поверхности, но и в глубине кристалла. На рис.13 видны два отрезка одной дислокационной петли и рождаемые ими новые дислокационные петли. Такая конфигурация называется источником Франка – Рида.

Рис. 13 Источник дислокаций в кристалле кремния, выявленный методом декорирования. Увеличение 600х
Недостатком метода декорирования является то, что дислокация, на которой выделялись частицы, уже не может двигаться. Поэтому метод декорирования непригоден для наблюдения за изменением дислокационной структуры, но в сочетании с травление он дает возможность сопоставить распределение дислокаций на поверхности с их распределением в глубине кристалла.
Метод фотоупругости
Собственные поля напряжений дислокации, складываясь, создают заметные концентрации напряжений внутри кристалла, которые можно наблюдать благодаря пъезооптическому эффекту (фотоупругости). Этот метод особенно удобен для исследования дислокаций в кубических кристаллах, которые в ненапряженном состоянии оптически изотропны. Поля напряжений дислокаций а них регистрируются по возникающему двойному лучепреломлению. На рис.14 показано распределение дислокаций в кристаллографической пластинке кремния, регистрируемое по методу травления, методу декорирования и по двойному лучепреломлению. Видно, что во всех случаях картины распределения дислокаций совпадают.
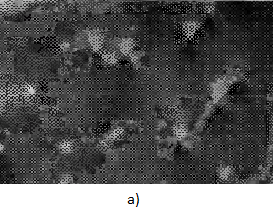
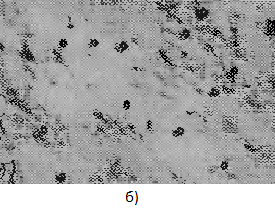


Рис. 14 Дислокационная структура пластинки кремяния, выявленная различными методами: а-напряжение вокруг дислокаций, видимые по двойному лучепреломлению в поляризованном свете; б – ямки травления на поверхности образца; в-декорирование дислокации; г-схема расположения дислокаций в образце. Стрелки указывают напрвление краевых компонент
По двойному лучепреломлению в поляризованном свете можно выявить характерную картину распределения напряжений вокруг отдельной дислокации, описываемого формулами (5.6)-(5.8) (рис. 15-16). Ряды дислокаций, скопившихся в плоскостях скольжения или в доменных стенках, видны в поляризационном свете как полосы двойного лучепреломления (рис.17).

Рис. 15 Расчетные поля напряжений вокруг отдельных краевых дислокаций в кристалле граната

Рис. 16 Поля напряжений вокруг отдельных краевых дислокаций в кристалле граната, экспереминтально наблюдаемые в поляризованном свете

Рис. 17 Полосы двупреломления вдоль плоскостей скольжения {110} в изогнутом кристалле фтористого лиия. Увеличение 60х
Электронная микроскопия и рентгеновские методы
Это самые мощные из экспериментальных методов прямого наблюдения дислокаций. Метод наблюдения дислокаций с помощью электронного микроскопа, применяемый очень широко, основан на эффекте дислокационного контраста, возникающего из-за взаимодействия электронного пучка со смещенными атомами в поле напряжений вокруг дефекта решетки. Вследствие интерференции между проходящими и дифрагированными электронными лучами в электронном микроскопе удается увидеть изображение линий дислокаций, дефектов упаковки, дислокационных рядов и стенок.
Возможности этого метода ограничены шириной пучка, позволяющей исследовать лишь небольшой участок кристалла и, главное, тем, что можно исследовать материалы лишь в виде тонких пленок толщиной не больше 100-500 нм. Для получения такой пленки материал прокатывается до тонкой фольги или утоньшается другими методами: резкой, механической или химической полировкой. Однако при всех этих обработках в пленку вносятся новые дефекты, поэтому дислокационная структура пленкине соответствует структуре массивного образца, т.е по получаемой картине нельзя одназначно судить о структуре исходного кристалла. Лучшие результаты получаются при исследовании выращенных тонких эпитаксиальных пленок, однако и здесь возникают специфические трудности, связанные с тем, что в таких тонких пленках влияние поверхности на образование и движение дефектов значительно больше и качественно иное, чем в массивных образцах, которые можно считать по сравнению с дислокацией практически бесконечными. Тем не менее методом электронной микроскопии получены основные данные о дислокационной структуре многих веществ, движении дислокаций, дефектах упаковки и взаимодействии различных дефектов решетки друг с другом (рис. 18-21). С помощью электронного микроскопа удается разрешать отдельные плоскости решетки и непосредственно видеть отдельные дислокации (см. рис. 21).


Рис. 18 Сетки дислокаций в плоскости (0001) вкристалле цинка. Рис. 19 Ряды атомов и краевая дислокация в кристалле CuS.


Рис. 20 Сетка дислокаций в кристалле кремнистого железа. Рис. 21 Ряды атомов и дислокации в тонкой пленке палладия,напыленный на монокристалл золот

Рис. 22 Дислокация в кристалле кремния толщинной 0,5 мм.
Метод рентгеновской топографии
Он дает возможность исследовать толстые и достаточно большие образцы. В этом методе используется брэгговское рентгеновское отражение, а дифракционный контраст получается из-за того, что локальная деформация решетки, связанная с дефектом, изменяет условия отражения и рассеяния рентгеновских лучей. Интенсивность дифрагированного рентгеновского пучка вблизи дефекта уменьшается, вследствие чего дефект виден как темная линия на общем светлом фоне (рис. 22).
Эти и многие другие, прямые или косвенные, методы позволяют видеть дислокации на поверхности или в объеме образца, следить за их движением и взаимодействием.
РЕНТГЕНОГРАФИЧЕСКИЕ МЕТОДЫ НАБЛЮДЕНИЯ ДИСЛОКАЦИЙ
Важнейшим дефектом кристаллов являются дислокации, приводящие к разориентировки соседних областей кристалла.
Одной из характеристик степени совершенства монокристаллов является плотность дислокаций  , определяемая как число выходов дислокаций на единицу поверхности.
Плотность дислокаций в кристаллах может изменяться от нуля (идеальный кристалл) до
, определяемая как число выходов дислокаций на единицу поверхности.
Плотность дислокаций в кристаллах может изменяться от нуля (идеальный кристалл) до  дислокаций на 1
дислокаций на 1
 . Последнее значение плотности дислокаций характерны для так называемого идеально-мозаичного кристалла.
. Последнее значение плотности дислокаций характерны для так называемого идеально-мозаичного кристалла.
Разработаны различные “прямые” методы определения плотности дислокаций в кристаллах: метод избирательного травления, методы рентгеновской топографии и т. д.
Наряду с ними развиваются рентгеновские методы определения плотности дислокаций  по интегральным интенсивностям брэгговских отражений.
Эти методы дают ряд преимуществ, главное из которых заключается в возможности определения значений плотности дислокаций в широком интервале значений без разрушения кристаллов.
по интегральным интенсивностям брэгговских отражений.
Эти методы дают ряд преимуществ, главное из которых заключается в возможности определения значений плотности дислокаций в широком интервале значений без разрушения кристаллов.
Характеристикой отражательной способности кристалла является интегральная интенсивность. Интегральная интенсивность-величина, определяющая полную энергию, рассеянную в направлении главного максимума.
Интегральную интенсивность можно определить по площади, ограничивающей кривую распределения интенсивности, получаемой при повороте кристалла около отражающего положения в интервале углов рассеяния
 ,
,  . В этом случае все блоки мозаики независимо от их ориентации пройдут через отражающее положение.
Интегральная интенсивность задается выражением:
. В этом случае все блоки мозаики независимо от их ориентации пройдут через отражающее положение.
Интегральная интенсивность задается выражением:

 – интенсивность первичного пучка рентгеновский лучей,
– интенсивность первичного пучка рентгеновский лучей, – интенсивность рассеянного рентгеновского излучения при данном угле падения
– интенсивность рассеянного рентгеновского излучения при данном угле падения ,
, – коэффициент интегрального отражения.
– коэффициент интегрального отражения.Пределы интегрирования выбраны так, чтобы интервал, ограниченный ими, полностью захватывал только один интерференционный максимум.
Теоретическая формула для расчета интенсивности интегрального отражения принимает совершенно различный вид, в зависимости от того, считаем мы, что кристалл является совершенным или что он является идеально-мозаичным. т.е. состоит из мелких, почти параллельных блоков с настолько малыми размерами. Что эффектом поглощения и многократного отражения рентгеновских лучей внутри него можно пренебречь. Реальный кристалл находится между двумя предельными состояниями кристалла.
Методы измерения интегральной интенсивности
Известны четыре способа измерения интегральной интенсивности:
- Кристалл и счетчик неподвижны.
- Кристалл вращается, счетчик неподвижен – метод
 - сканирования.
- сканирования. - Счетчик вращается со скоростью в 2 раза больше скорости вращения образца – метод
 - сканирования.
- сканирования. - Счетчик вращается, образец неподвижен.
При конечных размерах кристалла углы обратной решетки нельзя считать геометрическими точками, узлы поэтом размыты.
Это обстоятельство влияет на зависимость интегральной интенсивности от брэгговского угла. Пусть  – телесный угол.
Под которым из центра сферы отражения видно сечение этой сферой узла обратной решетки L (рис.1.).
– телесный угол.
Под которым из центра сферы отражения видно сечение этой сферой узла обратной решетки L (рис.1.).

Рис.1
Для получения кривых распределения интенсивности в зависимости от угла рассеяния, которое называют кривыми качания, используется метод двухкристального спектрометра.
В двухкристальном спектрометре рентгеновские лучи последовательно отражаются от двух плоских кристаллов, из которых первый имеет совершенное строение, а второй (исследуемый образец 2 – мозаичное.
Данный метод позволяет применять две схемы установки кристаллов. По первой схеме (рис.2, а) пучок рентгеновских лучей падает на совершенный кристалл 1, установленный в отражающем положении под брэгговским углом
 . Отражаемый от этого кристалла монохроматический пучок падает на исследуемый кристалл 2, установленный в отражающем положении, но его поверхность не параллельна поверхности кристалла 1.
Такое положение называется антипараллельным и обычно обозначается символом (m, n), где m и n – порядки отражения кристалла монохроматора и исследуемого кристалла соответственно.
Исследуемый кристалл поворачивают на небольшие углы в интервале
. Отражаемый от этого кристалла монохроматический пучок падает на исследуемый кристалл 2, установленный в отражающем положении, но его поверхность не параллельна поверхности кристалла 1.
Такое положение называется антипараллельным и обычно обозначается символом (m, n), где m и n – порядки отражения кристалла монохроматора и исследуемого кристалла соответственно.
Исследуемый кристалл поворачивают на небольшие углы в интервале  до тех пор, пока кристалл не выйдет из отражающего положения.
В антипараллельном положении дисперсии равна сумме угловых дисперсий каждого из кристаллов.
до тех пор, пока кристалл не выйдет из отражающего положения.
В антипараллельном положении дисперсии равна сумме угловых дисперсий каждого из кристаллов.
По второй схеме (рис.2, б) кристалл 2 располагают таким образом, чтобы его поверхность была параллельна поверхности кристалла 1. Идеальная параллельность может быть достигнута только в том случае, если оба кристалла изготовлены из одного и того же вещества, но отличаются совершенством строения. Такое расположение называют параллельным и обозначают символом (m, -n). В параллельном положении угловая дисперсия двухкристального спектрометра равна разности дисперсий каждого из кристаллов и в истинном параллельном положении равна нулю. В параллельном положении она не зависит от естественной ширины спектральной линии (дисперсия равна нулю), и определяется исключительно геометрическими и физическими факторами, т.е. структурным несовершенством. Поэтому для изучения степени мозаичности кристаллов удобнее всего применять параллельное расположение.

Рис.2, а

Рис.2, б
2 - исследуемый кристалл;
3,4,5 – коллимационные щели;
6 – детектор.
Методика измерения интегральных интенсивностей
В работе интегральные интенсивности рассеяния монокристаллов предлагается измерить на рентгеновской установке ДРОН-3.0 в молибденовом излучении, монохроматизированном отражении от монокристалла Si (111), установленном в первичном пучке. Для уменьшения расходимости первичного пучка установлены стандартный коллиматор и система щелей шириной 0.25 мм и высотой 0.08 мм.
В данной работе используется метод  - сканирования.
Кристалл выводится в отражающее положение таким образом, чтобы при его покачивании вокруг оси гониометра с угловой скоростью
- сканирования.
Кристалл выводится в отражающее положение таким образом, чтобы при его покачивании вокруг оси гониометра с угловой скоростью
 весь отраженный пучок рентгеновский лучей полностью попадал в щель детектора. Юстировка образца производится следующим образом. Образец устанавливается в стандартном держателе, позволяющем осуществлять вращение в своей плоскости.
Далее детектор выводится на расчетный угол
весь отраженный пучок рентгеновский лучей полностью попадал в щель детектора. Юстировка образца производится следующим образом. Образец устанавливается в стандартном держателе, позволяющем осуществлять вращение в своей плоскости.
Далее детектор выводится на расчетный угол  соответствующий отражению от плоскости (HKL) пучка с диной волны
соответствующий отражению от плоскости (HKL) пучка с диной волны
 . Оси вращения образца и счетчика расцепляются.
Перед счетчиком устанавливается щель шириной 0.1-0.25 мм, и путем перемещения счетчика добиваются получения максимума интенсивности.
Затем та же процедура юстировки повторяется при перемещении образца при фиксированном положении детектора, соответствующего
. Оси вращения образца и счетчика расцепляются.
Перед счетчиком устанавливается щель шириной 0.1-0.25 мм, и путем перемещения счетчика добиваются получения максимума интенсивности.
Затем та же процедура юстировки повторяется при перемещении образца при фиксированном положении детектора, соответствующего  .
В результате определяем значение угла по шкале образца
.
В результате определяем значение угла по шкале образца  .
Путем вращения кристалла в своей плоскости добиваемся максимума интенсивности. Правильность юстировки проверяется при изменении высоты щели пред счетчиком.
При правильной юстировке кристалла уменьшение высоты щели на 50% не должно приводить к уменьшению интенсивности рассеяния.
Далее оси вращения образца и счетчика жестко скрепляются, и выводится отражение от этой же плоскости, соответствующее длине волны
.
Путем вращения кристалла в своей плоскости добиваемся максимума интенсивности. Правильность юстировки проверяется при изменении высоты щели пред счетчиком.
При правильной юстировке кристалла уменьшение высоты щели на 50% не должно приводить к уменьшению интенсивности рассеяния.
Далее оси вращения образца и счетчика жестко скрепляются, и выводится отражение от этой же плоскости, соответствующее длине волны
 . После уточнения углов
. После уточнения углов  ,
,  ,
счетчик устанавливается под углом
,
счетчик устанавливается под углом  . Щели перед счетчиком удаляется. Рассчитывается среднее значение угла установки образца.
Образец сканируется в интервале углов
. Щели перед счетчиком удаляется. Рассчитывается среднее значение угла установки образца.
Образец сканируется в интервале углов  -
-  ,
,  .
Значения интегральной интенсивности каждого отражения получаются в результате усреднения не менее 2-х измерений, полученных в результате сканирования “вперед-назад”.
Кроме того для минимизаций погрешности, связанной с возможным отклонением отражающей плоскости от поверхности кристалла, образцы следует рентгенографировать в положениях
.
Значения интегральной интенсивности каждого отражения получаются в результате усреднения не менее 2-х измерений, полученных в результате сканирования “вперед-назад”.
Кроме того для минимизаций погрешности, связанной с возможным отклонением отражающей плоскости от поверхности кристалла, образцы следует рентгенографировать в положениях
 .
Фон измеряется на “хвостах” линии с обеих сторон от максимума за 100 сек. и усредняется. Интервал углов сканирования необходимо задавать таким образом.
Чтобы фон на “хвостах” кривой качания с обеих сторон был примерно одинаков (отличие в значениях интенсивности рассеяния не должно выходить за рамки погрешности эксперимента) (рис.3).
.
Фон измеряется на “хвостах” линии с обеих сторон от максимума за 100 сек. и усредняется. Интервал углов сканирования необходимо задавать таким образом.
Чтобы фон на “хвостах” кривой качания с обеих сторон был примерно одинаков (отличие в значениях интенсивности рассеяния не должно выходить за рамки погрешности эксперимента) (рис.3).
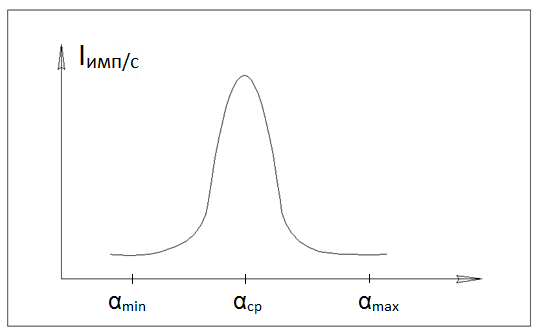
Рис.3
Экспериментальные значения интегральной интенсивности рассеяния  определяется по формуле (2):
определяется по формуле (2):

E - полная энергия, рассеянная в направлении главного максимума (имп),
 - интенсивность фона (имп/сек),
- интенсивность фона (имп/сек),T - время сканирования образца (сек),
 - угловая скорость вращения образца (рад/сек),
- угловая скорость вращения образца (рад/сек), - интенсивность первичного пучка (имп/сек).
- интенсивность первичного пучка (имп/сек).При нахождении интегральных интенсивностей важную роль играет измерение интенсивности первичного пучка.
Измерение интенсивности первичного пучка необходимо производить несколько раз до и после сканирования образца.
Интенсивность первичного пучка измеряется после ослабления пакетом фильтров -  , где
, где
 коэффициент ослабления, в данной работе равен 28.7.
коэффициент ослабления, в данной работе равен 28.7.
ЭКСТИНЦИОННЫЙ ПАРАМЕТР. МЕТОДИКА РАСЧЕТА ТЕОРЕТИЧЕСКОЙ ЗАВИСИМОСТИ 

Точное значение интегральной интенсивности строго теоретически можно получить только для двух крайних типов кристалла-совершенного и идеально-мозаичного.
Совершенным кристаллом принято считать кристалл, состоящий из параллельных плоскостей, неподвижные атомы в которых из параллельных плоскостей, неподвижные атомы в которых образуют правильную систему точек.
Расчет интегральных интенсивностей (R) ведется на основе динамической теории, которая оперирует с амплитудами рассеянных волн -  .
.
Мозаичным называют кристалл, состоящий из очень большого числа настолько малых блоков, чтобы поглощением в них можно было пренебречь.
Причем эти блоки разориентированы друг относительно друга так, что отражение от них можно считать оптически независимыми.
Это значит, что между ними не существует закономерного соотношения фаз. Поэтому для получения полной интенсивности отражения таким идеально-мозаичным кристаллом достаточно просто сложить интенсивности отражений каждым отельным блоком.
Расчет интегральной интенсивности отражений в этом случае  ведется на основе кинематической теории.
ведется на основе кинематической теории.
Эти два значения интегральной интенсивности  и интегральной интенсивности реального кристалла находится в области значений
и интегральной интенсивности реального кристалла находится в области значений
 и
и  , причем для брэгговской геометрии справедливо соотношение, причем для брэгговской геометрии справедливо соотношение
, причем для брэгговской геометрии справедливо соотношение, причем для брэгговской геометрии справедливо соотношение
 . Поэтому можно записать:
. Поэтому можно записать:

Несоответствие теоретических и экспериментальных интегральных интенсивностей объясняется экстинкционными эффектами.
Различают первичную и вторичную экстинкции. Первичной экстинкцией называют уменьшение интенсивностей за счет динамического взаимодействия падающего и отраженного лучей в идеальном кристалле.
Чтобы понять возникновение первичной экстинкции, рассмотрим модель совершенного кристалла, предложенную Дарвиным (рис.4).
Пусть кристалл находится в отражающем положении.
Тогда первичный пучок, проходя через кристалл, поглощается. Поглощение характеризуется линейным коэффициентом поглощения
 . Если кристалл находится в отражающем положении под брэгговским углом
. Если кристалл находится в отражающем положении под брэгговским углом  ,
то отраженные от атомных плоскостей лучи падают на лежащие выше атомные плоскости под углом
,
то отраженные от атомных плоскостей лучи падают на лежащие выше атомные плоскости под углом  и испытывают повторное отражение.
и испытывают повторное отражение.

Рис.4
Вторично отраженные лучи отстают по фазе на угол
 .
В результате взаимодействия первичной и отраженной волн происходит ослабление интенсивности первичного пучка.
.
В результате взаимодействия первичной и отраженной волн происходит ослабление интенсивности первичного пучка.Уменьшение интегральной интенсивности за счет экранировки нижних блоков верхними в мозаичном кристалле называют вторичной экстинкцией.
Пусть кристалл состоит из блоков, незначительно разориентированных друг относительно друга (рис.5).
Тогда интенсивность первичного пучка, дошедшего до блока 2, ослабляется в  ,
,
где  -линейный коэффициент поглощения, s- путь первичного пучка в кристалле до блока 2.
Если же на пути первичного пучка встретиться еще один блок 1, ориентированный аналогично блоку 2, то интенсивность первичного пучка будет уменьшена вследствие отражения блоком 1.
-линейный коэффициент поглощения, s- путь первичного пучка в кристалле до блока 2.
Если же на пути первичного пучка встретиться еще один блок 1, ориентированный аналогично блоку 2, то интенсивность первичного пучка будет уменьшена вследствие отражения блоком 1.

Рис.5
Теоретические формулы для интегральной интенсивности вычислены Дарвиным для “толстого” кристалла в форм плоскопараллельной пластины:
1) для идеального кристалла без учета поглощения-
2) для идеально-мозаичного кристалла-

Для дальнейших расчетов удобно ввести величину интегрального отражения единицей объема-

N - число элементарных ячеек в единице объема (
 , а-период элементарной ячейки),
, а-период элементарной ячейки), - длина волны используемого излучения,
- длина волны используемого излучения,F - структурная амплитуда,
 - структурный фактор,
- структурный фактор,
 - функция атомного рассеяния j-го узла подрешетки,
- функция атомного рассеяния j-го узла подрешетки,n - число узлов,
h,k,l - индексы интерференции,
 – координаты j-ого атома,
– координаты j-ого атома, – классический радиус электрона, равный
– классический радиус электрона, равный  см,
см, - температурный фактор или фактор Дебая-Валлера,
- температурный фактор или фактор Дебая-Валлера,
h - постоянная Панка (
 эрг*сек),
эрг*сек), - масса атома (г),
- масса атома (г), – постоянная Больцмана(
– постоянная Больцмана(  эрг.град),
эрг.град),  – характеристическая температура Дебая (К),
– характеристическая температура Дебая (К),  – функция Дебая,
– функция Дебая, x - аргумент этой функции,
 ,
, T - абсолютная температура проведения эксперимента (К),
 – поляризационный фактор, зависящий от геометрии съемки и в данной работе при использовании монохроматизации первичного пучка, равный:
– поляризационный фактор, зависящий от геометрии съемки и в данной работе при использовании монохроматизации первичного пучка, равный: 
 - брэгговский угол монохроматора,
- брэгговский угол монохроматора, - фактор Лоренца, равный
- фактор Лоренца, равный 
 – абсорбционный множитель (см – для бесконечно толстого кристалла равен -
– абсорбционный множитель (см – для бесконечно толстого кристалла равен - 
В работе экспериментальные значения интегральной интенсивности будем сравнивать с теоретическими значениями, рассчитанными по формуле (6) для толстого кристалла. Т.е.

Таким образом, рассчитав  , определить из эксперимента
, определить из эксперимента  , по формуле (3) находим значение экстинкционнго параметра y.
, по формуле (3) находим значение экстинкционнго параметра y.
Теоретическая формула зависимости экстинкционного параметра от плотности дислокаций для брэгговского случая “толстого” кристалла имеет вид:




 - рассчитывается по формуле:
- рассчитывается по формуле: 
Порядок выполнения работы
- Измерить интенсивность первичного пучка после ослабления пакетом фильтров.
- Рассчитать брэгговские углы дифракции
 и
и  для исследуемых монокристаллов.
для исследуемых монокристаллов. - Получить интегральные интенсивности отражений (200) и (400) от монокристаллов.
- Рассчитать
 по формуле (2).
по формуле (2). - Рассчитать фактор Дебая-Валлера, поляризационный фактор, фактор Лоренца, используя справочные данные 1,2 и формулы (7-10) для указанных выше отражений.
- Рассчитать
 для от этих же отражений по формуле (12).
для от этих же отражений по формуле (12). - Найти значения экстинкционного параметра по формуле (3).
- По формулам (13-15) построить теоретические зависимости экстинкционального параметра от плотности дислокаций
 для двух порядков отражений – (200) и (400).
для двух порядков отражений – (200) и (400). - По полученным графикам определить значения искомой плотности дислокаций.
- Оценить экспериментальную погрешность определения интегральной интенсивности отражений, погрешность в определении фона, и затем погрешность в определении фона дислокаций.
 .
.| a, A |  |
 |
 |
 |
 |
Если исследуемый монокристалл представляет собой соединение или твердый раствор, то массовые коэффициенты поглощения вычисляются из соотношения:
 , где
, где  - массовый коэффициент поглощения,
- массовый коэффициент поглощения,
 - плотность вещества (не путать с плотность дислокаций!)
- плотность вещества (не путать с плотность дислокаций!)
i - число компонент в соединении,
 - весовая доля i-го компонента,
- весовая доля i-го компонента, - функция атомного рассеяния без учета дисперсионных поправок,
- функция атомного рассеяния без учета дисперсионных поправок, и
и  первая и вторая дисперсионные поправки соответственно.
первая и вторая дисперсионные поправки соответственно.

 |
(HKL) |  |
 |
 |
 |
 |
 |
| (200) | |||||||
| (400) |
| (HKL) | № |  , имп/с , имп/с |
 , имп/с , имп/с |
t, сек | Е, имп |
| (200) | 1 | ||||
| 2 | |||||
| Среднее: | |||||
| (400) | 1 | ||||
| 2 | |||||
| Среднее: |
| (HKL) |  |
 |
 |
 |
| (200) | ||||
| (400) |

 |
0 | 10 |  |
 |
 |
 |
| y | ||||||
 |
 |
 |
 |
 |
 |
 |
| y |
Контрольные вопросы
- Что понимают под совершенным и идеально-мозаичным кристаллом?
- Что такое плотность дислокаций и каковы способы ее определения?
- В чем заключается метод определения плотности дислокаций в данной работе?
ЛАБОРАТОРНАЯ РАБОТА
Определение плотности дислокаций методом оптической микроскопии
Теоретическая часть
Большинство материалов относятся к кристаллическим веществам, в которых составляющие их частицы (атомы, ионы, молекулы) расположены в периодически повторяющейся последовательности.
Многообразие физических свойств большинства материалов определяются их структурой. Понятие структуры в применении к этим объектам включает в себя:
а) особенности строения, видимые либо визуально, либо при помощи оптических приборов, дающих небольшие ( до х30) увеличения.Такие характеристики определяются термином “макроструктура”;б) межфазные границы, размеры и формы включений присутствующих фаз и их количественное соотношение: размеры и форсы зерен для однофазных систем. Этот комплекс понятий объединяется в термин “микроструктура”. Микроструктура выявляется при использовании оптических приборов, дающих увеличение (х30, х1500) и электронной микроскопии (до х50000);
в) атомно-молекулярное строение или субмикроструктура.
Субмикроструктура изучается с помощью электронных микроскопов и методами дифракции рентгеновских лучей или нейтронов.
Металлографические исследования позволяют получать сведение о микроструктуре объектов (шлифов). При помощи металлографического анализа можно решать достаточно корректно 3 задачи:
1. Определение среднего размера зерен однофазных материалов;2. Нахождение средних размеров фазных включений или распределение фазных включений по размерам;
3. Определение относительного содержания фаз в двух- или в многофазных системах.
4. Под фазой понимают часть или совокупность гомогенных частей системы, отделенных от других частей системы поверхностью раздела и характеризующихся в отсутствии внешних воздействий одинаковыми свойствами и составом во всех своих точках.
Ход лучей в оптическом микроскопе показан на рис.6.

Рис.6. схема формирования изображения в оптическом микроскопе:
1 - передняя фокальная плоскость объектива, 2 - обратная(или задняя)фокальная плоскость объектива, 3 - передняя фокальная плоскость окуляра, 4 - задняя фокальная плоскость окуляра.
Максимальное (полезное) увеличение микроскопа зависит от разрешающей способности глаза и микроскопа и может быть определено, используя соотношение:

 – максимальная разрешающая способность человеческого глаза, равная 0,3 мм;
– максимальная разрешающая способность человеческого глаза, равная 0,3 мм; – максимально разрешающая способность оптического микроскопа.
– максимально разрешающая способность оптического микроскопа.Увеличение сложного микроскопа определяется формулой:

где
 - расстоянмие от объектива до изображения
- расстоянмие от объектива до изображения  (см. рис.6),
D - наименьшее расстояние нормального зрения (~25 см для большинства людей),
(см. рис.6),
D - наименьшее расстояние нормального зрения (~25 см для большинства людей),
 и
и  - фокусное расстояние линз объектива и окуляра.
Величины
- фокусное расстояние линз объектива и окуляра.
Величины  и
и  обычно называют увеличением объектива и окуляра соответственно.
обычно называют увеличением объектива и окуляра соответственно.Практическое увеличение микроскопа определяется произведением увеличения окуляра
 на увеличение объектива
на увеличение объектива  .
.
Практическая часть
Цель работы: Определение плотности дислокаций монокристалла кварца методами оптической микроскопии.Оборудование: Металлографический микроскоп МЕТАМ
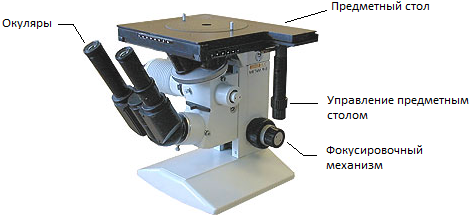
- Установить увеличение микроскопа.
Увеличение микроскопа зависит от параметров объектива и окуляра и рассчитывается по формуле . Подберите увеличение объектива и окуляра таким образом, чтобы увеличение микроскопа М=500.
. Подберите увеличение объектива и окуляра таким образом, чтобы увеличение микроскопа М=500. - Определить цену деления при помощи объект-микрометра.
Цена деления объект-микрометра 0,01мкм. - На поверхности образца выбрать 10 полей. Подсчитать число выходов дислокаций N на поверхность. Результат усреднить (
 ).
). - Рассчитать среднюю плотность дислокаций по формуле:

где
 - плотность дислокаций,
- плотность дислокаций, 
 - среднее число выходов дислокаций.
- среднее число выходов дислокаций.S - площадь поля зрения окуляра микроскопа,

| Образец | Изображение | Измерения | 1 |  |
 |
|---|---|---|
 | 2 |  |
Дислокаций нет |
| 3 |  |
 |
 | 4 |  |
Дислокаций нет |
| 5 |  |
 |
 | 6 |  |
 |
 | 7 |  |
 |
 | 8 |  |
Дислокаций нет |
Контрольные вопросы
- Что называется дислокацией? Перечислите типы дислокаций и объясните их строение.
- Перечислите методы наблюдения дислокаций. Сформулируйте преимущества и ограничения каждого метода.
- Объясните механизм образования ямок травления в местах выхода дислокаций на поверхность при химическом травлении.
- Как влияет наличие дефектов в образце на вид дифракционного профиля?
- Дайте определение понятиям «макроструктура», «микроструктура» и «субмикроструктура».
Рекомендуемая литература
- Джеймс Р. Оптические принципы дифракции рентгеновских лучей. М.: Изд-во ИЛ, 1950. 572 с.
- Русаков А.А. Рентгенография металлов. М.: Атомиздат, 1977. 477 с.
- Шиврин О.Н. Дифракция рентгеновских лучей в кристаллах. Петрозаводск, 1980. 108 с.
- Кузнецов А.В. Рентгенографическое определение плотности дислокаций в кристаллах и учет эффектов экстинкции. Петрозаводск, 1981. 68 с.
- Кузнецов А.В. О применимости формул Захариасена для подсчета интегральной мощности, рассеянной “толстым” монокристаллом в брэгговском симметричном случае, при любых плотностях дислокаций// Кристалография. 1973. Т.18. Вып.5. С. 944-949.
- Е.А. Репникова Физическое материаловедение. Учебное пособие. Петрозаводск: Изд-во ПетрГУ, 2008. 86 с.
- Шаскольская М.П. Кристаллография. Т.1.М.: Атомиздат, 1995. 448 с.
- Микроскопический анализ фазового состава и структуры металлов и сплавов: метод. указ./ сост. Е.А Репникова. Петрозаводск: Изд-во ПетрГУ, 1994. 23 с.

